摘要:为了探究阳离子表面活性剂对A向(1120)蓝宝石晶片化学机械抛光效率的影响,采用失重法计算蓝宝石的材料去除率(MRR)、原子力显微镜观察抛光后蓝宝石晶片表面粗糙度(Ra)。结果表明:纯二氧化硅磨粒抛光液中,蓝宝石晶片的MRR在pH8时最优(MRR=1984/h),此时Ra为0.867 nm;添加一定浓度的阳离子表面活性剂可以提高蓝宝石晶片的抛光效率,其MRR在pH=9时达到最大(MRR=2366 nm/h),此时Ra=0.810 nm。通过粒径和Zeta电位分析,阳离子表面活性剂改变了二氧化硅磨粒表面的Zeta电位值,进而改变了磨粒与磨粒及磨粒与蓝宝石晶片的作用力,且在碱性条件下可以获得较高的MRR。
关键词:蓝宝石晶片;化学机械抛光;阳离子表面活性剂;材料去除率;pH值
1 引 言
蓝宝石是氧化铝(α-Al2O3)的单晶形式,由于其高强度、高硬度、高透过率和化学惰性等优秀的机械、光学及化学特性,是光学、电子和半导体应用最广泛的单晶材料之一,如在国防、航空航天等技术领域的红外窗口片以及精密光学部件上的应用[1-3]。作为窗口材料,对晶体表面质量提出了更高的要求,但是由于A向蓝宝石晶片具有高的硬度,如果单纯采用机械抛光方法,无论是氧化铝或者二氧化硅粉末还是硬度极高的金刚石粉末都没有较高的抛光效率,而单一的化学抛光往往会使蓝宝石晶片产生雾斑,降低表面质量[4-6]。化学机械抛光(CMP)作为目前唯一可以实现全局平坦化的抛光技术[7-8],其通过化学和机械的共同作用,获得良好的抛光效果[9],得到超光滑表面,已应用于很多材料的抛光。
目前大多研究是对C向蓝宝石的化学机械抛光,熊伟等[10]用三种不同的磨料(SiC、Al2O3、SiO2 )对C向蓝宝石进行化学机械抛光,发现二氧化硅的分散效果最好,去除速率最大,并研究了不同粒径的二氧化硅对材料去除率(MRR)和表面质量的影响,发现粒径越大MRR就越高,但表面粗糙度相对较高。由于蓝宝石具有各向异性,A向蓝宝石原子排列最紧密,其平均质量远高于C向蓝宝石[11-12],朱红林等[13]在相同的条件下用氧化铝抛光液分别对C向、A向和M向的蓝宝石晶片进行化学机械抛光,发现MRRc>>MRRa>MRRm,分析结果表明A向和M向蓝宝石几乎不能与抛光液发生化学反应,所以去除率很低。王金普等[14]用纳米氧化铝作为磨料、络合剂用氟化铵对A向蓝宝石进行化学机械抛光,也没明显提高蓝宝石的MRR,且氧化铝硬度过高,造成材料表面划痕比较严重,表面粗糙度较高。本实验结合其他学者对蓝宝石的化学机械抛光研究,采用二氧化硅为磨粒,并添加一定浓度的阳离子表面活性剂来探究A向蓝宝石晶片的材料去除速率及表面去除机理。
2 实 验
2.1 实验材料
抛光片采用直径为2 inch、厚度为460 μm的A向蓝宝石晶片(安泰科光电技术有限公司),二氧化硅溶液(粒径为80 nm,浓度为30wt%,宣城晶锐新材料有限公司),阳离子表面活性剂选用十六烷基三甲基溴化铵(国药集团,≥99.0%),有机硅消泡剂,pH调节剂采用KOH(国药集团,≥85%)和硝酸(国药集团,70%)。活性剂均需先溶于300~500 mL的去离子水中磁力搅拌20 min,抛光液的配制均在磁力搅拌的条件下进行。
2.2 化学机械抛光实验
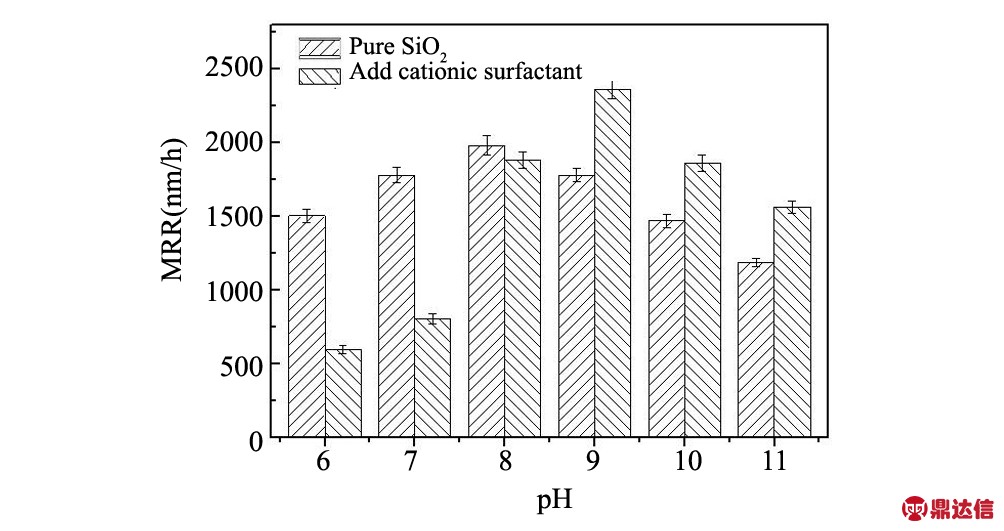
图1 纯SiO2溶液和添加0.015wt%阳离子表面活性剂后在不同pH值条件下的MRR
Fig.1 MRR of Pure SiO2 solution and 0.015wt% cationic surfactant in different pH value
抛光前将A向蓝宝石晶片在去离子水中超声清洗20 min,再用酒精超声清洗20 min以去除表面杂质,抛光实验在UNIPOL-1200S 自动压力研磨抛光机上进行,选用无纺布型抛光垫,抛光工艺的基本参数:压力为2 Psi,上下盘转速均为80 r/min,抛光液流速为90 mL/min。分别用pH值为6、7、8、9、10、11的纯二氧化硅抛光液和添加阳离子表面活性剂的抛光液抛光20 min,每组抛光参数至少重复抛光三次并求其平均值。材料去除率采用失重法在电子天平(Mettler Toledo AG 285,精度0.01 mg)上对抛光前后的蓝宝石晶片进行称重,具体计算公式如下:
MRR=(106△m)/(ρπr2 t)
(1)
其中,△m 为A向蓝宝石抛光前后的变化值(单位g), ρ 为蓝宝石晶体的密度(3.98 g/cm3), r为蓝宝石晶片的半径(单位mm),t为抛光时间(单位h)。
3 结果与讨论
3.1 抛光结果及表面形貌
图1是添加阳离子表面活性剂前后不同pH值下抛光A向蓝宝石晶片的MRR。由图1可以看出,添加阳离子表面活性剂前后A向蓝宝石晶片的MRR都随着pH值的增加先逐渐提高然后降低,分别在pH=8(MRR=1984 nm/h)和pH=9(MRR=2366 nm/h)时达到最大。进一步分析可知,pH值在6~8时,添加阳离子表面活性剂降低了A向蓝宝石晶片的MRR,在pH值9~11时添加阳离子表面活性剂可以提高A向蓝宝石晶片的MRR。
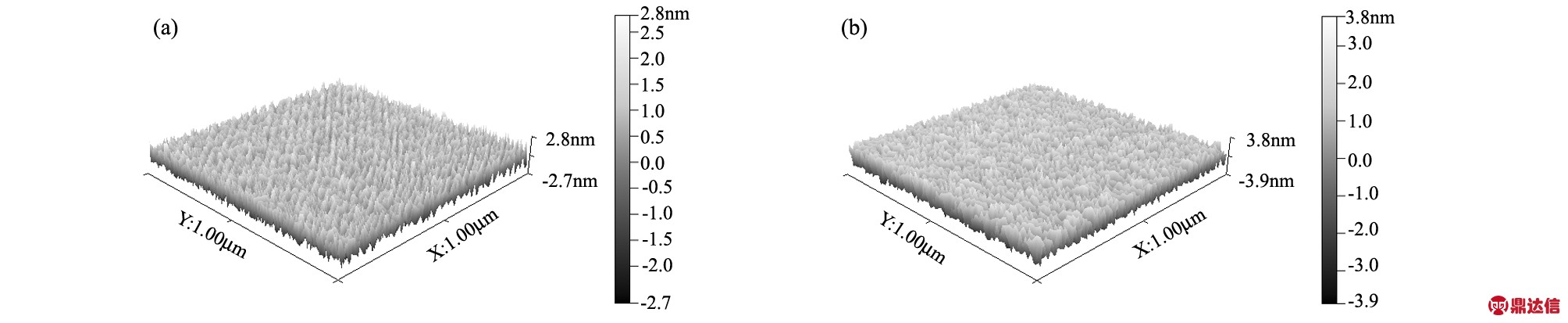
图2 纯SiO2溶液抛光后的AFM (a)pH=8;(b) pH=9
Fig.2 AFM after polishing by pure SiO2 solution (a)pH=8; (b) pH=9
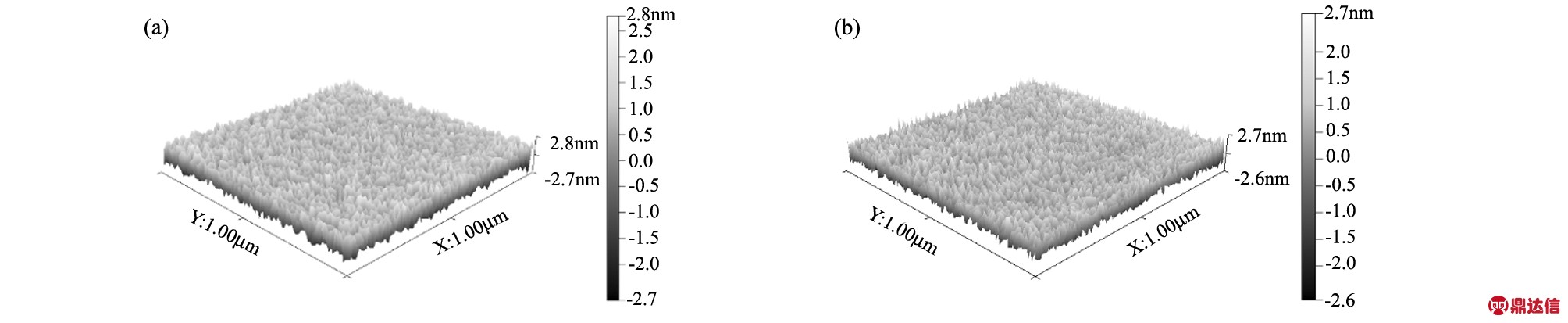
图3 添加0.015wt%的表面活性剂抛光后的AFM (a)pH=8;(b) pH=9
Fig.3 AFM after polishing by 0.015wt% cationic surfactants (a)pH=8; (b) pH=9
图2和图3是在pH=8和pH=9时经纯二氧化硅和添加0.015wt%的表面活性剂抛光后的表面形貌。由图2可以看出,经pH=8的纯二氧化硅抛光后的表面粗糙度(Ra=0.867 nm)低于pH=9的纯二氧化硅抛光后的表面粗糙度(Ra=1.262 nm),由图3知,添加0.015wt%的表面活性剂后,经pH=8抛光后的表面粗糙度(Ra=0.921 nm)高于pH=9抛光后的表面粗糙度(Ra=0.810 nm)。
3.2 粒度分析
抛光液的分散稳定性是提高材料去除率的因素之一,如图4是纯二氧化硅溶液在不同pH值下磨粒的粒径分布。由图4可知,纯二氧化硅溶液在pH=6和pH=7时有轻微的团聚,抛光液处于亚稳定状态,抛光过程中晶片表面容易出现划痕。在pH=8到pH=11时,二氧化硅粒径分布较均匀,平均粒径有所降低。在图1和图3中得知,纯二氧化硅时在pH=8抛光效果最好,这是因为在pH=8时二氧化硅磨粒的分散性较好,稳定性相对较高,抛光过程中抛光液与蓝宝石之间的化学作用及磨粒与晶片表面的机械作用的协同效果较好[9],随着pH值的增加,二氧化硅会因为强碱作用发生溶解,造成磨粒粒径减小[15],另外,碱性环境中二氧化硅表面的水合作用会降低二氧化硅的硬度[16],抛光过程中生成的反应产物,机械作用来不及去除[17],破坏了化学与机械的协同作用,所以在碱性环境中,纯二氧化硅抛光蓝宝石随着pH值的增加MRR降低,并且化学作用的不断增强,晶片表面容易出现雾斑。如图5是添加阳离子表面活性剂后在不同pH值下磨粒的粒径分布,由图5 知,添加0.015wt%的阳离子表面活性剂后二氧化硅磨粒有明显的团聚现象,降低了抛光液的稳定性,尤其在pH=6~8时较为严重,在图1中得知添加阳离子表面活性后pH=9时的抛光效果最好,这可能是因为添加阳离子表面活性剂改变了磨粒与晶片之间的作用力。进而改变了参与抛光过程中参与抛光的有效磨粒数量,并在pH=9时化学作用与机械作用的协同效果最好。
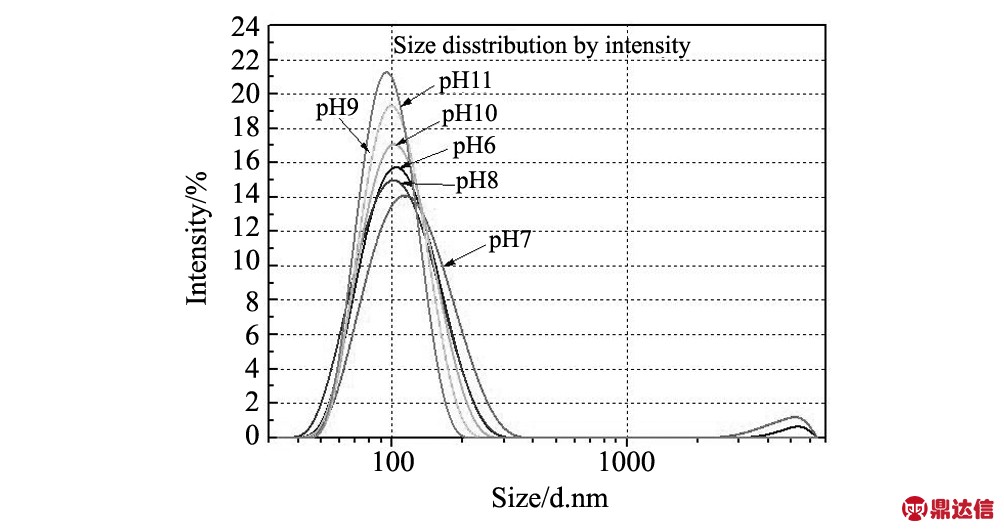
图4 不同pH值下的纯二氧化硅的粒径分布
Fig.4 Particle size of pure silica at different pH values
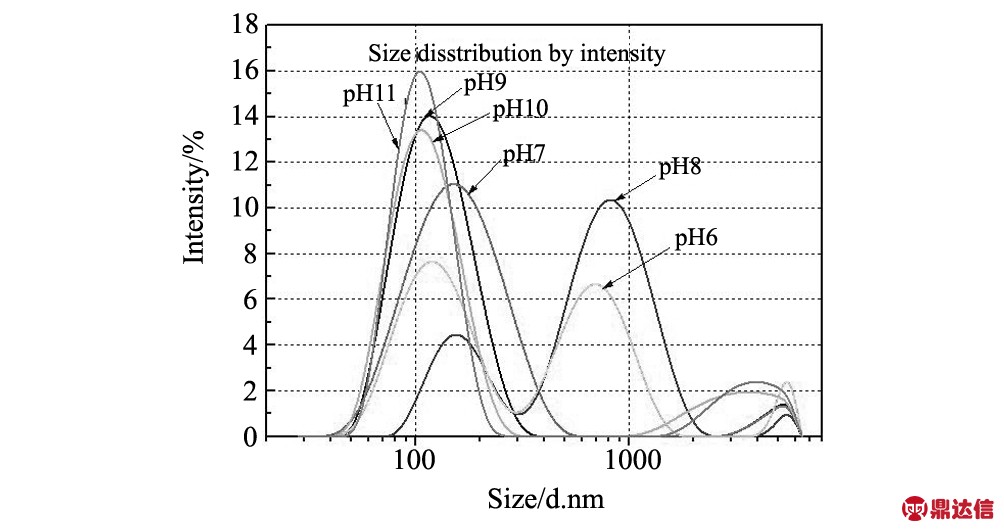
图5 添加0.015wt%的阳离子表面活性剂后不同pH值下的粒径分布
Fig.5 Particle size after adding 0.015wt% cationic surfactant at different pH values
3.3 Zeta电位分析
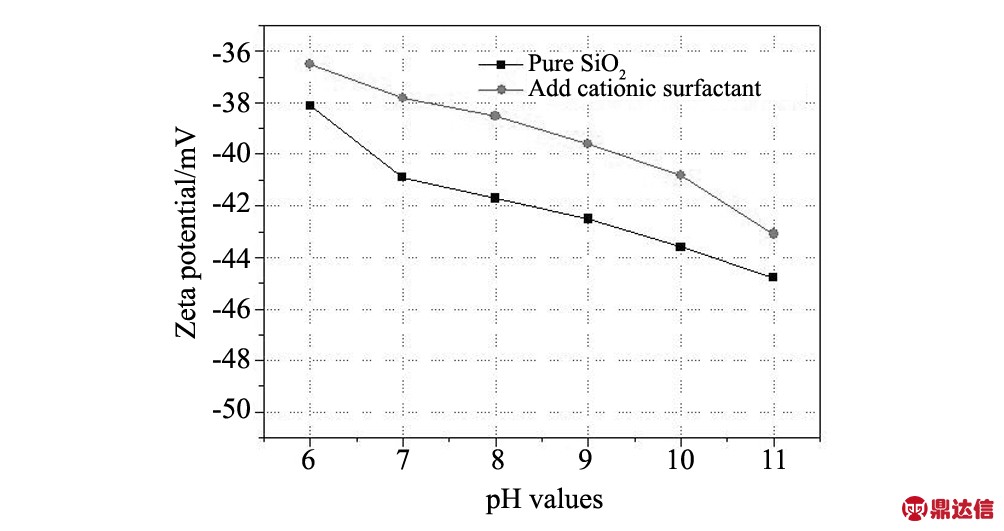
图6 不同pH值下的Zeta电位
Fig.6 Zeta potentials in different pH values
为进一步分析磨粒与晶片及磨粒与晶片之间的作用力,对纯二氧化硅磨粒和添加0.015wt%的阳离子表面活性剂后的二氧化硅磨粒表面进行了Zeta电位分析。图6是纯二氧化硅抛光液和添加阳离子表面活性剂后不同pH值下的Zeta电位。由图6可以看出,添加阳离子表面活性剂前后Zeta电位的绝对值都随着pH值增大而增大,但在相同pH值时,纯二氧化硅颗粒表面的Zeta电位绝对值比添加阳离子表面活性剂后大,这是因为带正电的阳离子表面活性剂吸附在二氧化硅粒子表面从而使二氧化硅颗粒表面的负电荷得到部分中和[18],使二氧化硅粒子间斥力减小,粒子间的静电斥力不足以阻止由于布朗运动产生的粒子之间相互引力,使颗粒更易聚集,降低抛光液的分散稳定性。以上分析表明,二氧化硅分散稳定性受粒子间静电力的影响,与经典的DLVO理论相吻合[19]。这也是在pH=6~8时添加阳离子表面活性剂降低蓝宝石晶片MRR的主要原因。
由图6可知,添加阳离子表面活性剂前后磨粒表面Zeta电位的绝对值都随pH值的增大而增大,而蓝宝石在去离子水中的零电位点约为pH=5[20],则在碱性环境中,磨粒与蓝宝石之间的静电斥力也逐渐增大,抛光过程中参与抛光的有效磨粒逐渐减少,降低晶片MRR,但添加阳离子表面活性剂后负电荷得到部分中和,静电斥力减小,可提高抛光过程中参与抛光的有效磨粒,增强抛光过程中的机械作用,这也是在pH=9~11时添加阳离子表面活性剂提高蓝宝石晶片MRR的主要原因。另外,表面活性剂可以加速反应物和反应产物之间的质量传递作用,进而提高抛光效率。
3.4 机理分析
蓝宝石(α-Al2 O3)是典型的两性氧化物,既可与酸发生化学反应,也可与碱发生化学反应。由图4知,以二氧化硅为磨粒的抛光液,在碱性的条件下抛光液的稳定性相对较好,尤其在抛光蓝宝石时通常采用碱性抛光液[21-23]。根据以往研究,在碱性抛光液中,蓝宝石会先发生水解反应及与OH-混合反应。具体化学式如下:
Al2O3+H2O=2AlO(OH)
(2)
Al2O3+3H2O=2Al(OH)3
(3)
Al2O3+2OH-=2AlO2-+H2O
(4)
Al(OH)3+OH-=2AlO2-+2H2O
(5)
AlO(OH)+OH-=2AlO2-+2H2O
(6)
抛光液中二液氧化硅与水的反应如下:
(SiO2 )x+2H2O=(SiO2 )(x-1)+Si(OH)4
(7)
为了深入了解化学反应层的生成机理,Vork等[24]从反应层深度对蓝宝石的表面反应层进行详细的XPS分析,并深度剖析对比不同晶向的蓝宝石晶片的元素含量变化,发现C向、R向、A向反应层的元素比例均接近Al∶Si∶O=2∶1∶5,认为表面反应层是Al2SiO5铝硅酸盐,再通过机械作用将其去除。
Si(OH)4+2AlO2-=Al2SiO5+2OH-+H2O
(8)
4 结 论
(1)纯二氧化硅条件下,A向蓝宝石的材料去除率(MRR)在pH=8时最大,这是因为pH=8时二氧化硅磨粒的分散性较好,抛光液的稳定性较高,抛光过程中抛光液与蓝宝石之间的化学作用及磨粒与晶片表面的机械作用的协同效果较好。
(2)向二氧化硅抛光液中添加阳离子表面活性剂造成胶体二氧化硅团聚,降低了抛光液的稳定性,但可以提高蓝宝石的材料去除率,同时降低蓝宝石晶片的表面粗糙度,阳离子表面活性剂改变了二氧化硅磨粒表面的Zeta电位值,进而改变了磨粒与蓝宝石晶片的作用力,增加抛光过程中的有效磨粒,进而提高MRR。



