摘要:ZnGeP2晶体在2~2.5 μm有几个吸收峰, GeZn及VZn这两种点缺陷对此波段吸收峰产生影响。利用实验与模拟计算相结合方法进行研究,首先通过理论计算的方法确定了理想ZnGeP2晶体的电子本征吸收和自由激子吸收引起的吸收位能量大于1.85 eV区间,对应的波长小于670 nm。其次通过实验的方法采用过量0.5at%Ge的非化学计量配比,生长出了有大量的GeZn缺陷的晶体,再在富P的环境下退火。通过与化学计量比生长的ZnGeP2晶体吸收谱对比分析得知:2~2.3 μm的吸收峰主要是GeZn缺陷产生的,2.4 μm以后的吸收峰为VZn点缺陷产生。最后基于密度泛函理论,运用VASP软件包来进行第一性原理计算,验证了这一结论。
关键词:ZnGeP2;GeZn点缺陷;VZn点缺陷;红外吸收谱
1 引 言
ZnGeP2(ZGP)晶体是中红外领域重要的激光变频材料[1], 相较于同样商业化的AgGeS2和AgGaSe2晶体具有更高的非线性系数:d36=75 pm/V[2],同时其具有双折射率适中,热导率高,透过范围覆盖第一大气窗口等优点, 已经广泛的应用于非线性光学器件领域,尤其是用于光学参量振荡,可通过2 μm的光学参量震荡(OPO)高效地产生连续稳定的3~8 μm激光[3]。
目前,ZGP晶体生长的主要途径为垂直布里奇曼法(VB)和水平梯度冷凝法(HGF)。但生长的晶体在0.7~2.5 μm存在较宽的额外吸收,使得ZGP晶体在OPO过程中的转换效率受到强烈影响。1.2 μm附近的额外吸收峰被证实部分来源于VZn的内部跃迁[4],该吸收峰的位置约为1 μm,并且尾部会延伸到接近2 μm。而2~2.5 μm附近对ZGP器件性能影响更加重要的吸收峰还有待更进一步的研究。
2 实验与讨论
2.1 本征无缺陷ZGP晶体光学性能的理论计算研究
为了确定本征吸收对于ZGP晶体光学性能的作用,首先对化学计量比合成生长的ZGP晶体进行紫外可见吸收光谱的测试。使用PerkinElmer Lambda 950对打磨、抛光后单晶片进行近红外吸收光谱测试。测试晶片厚度为3 mm,测试温度为298 K,光谱测试范围1~2.5 μm。结果如图1所示。
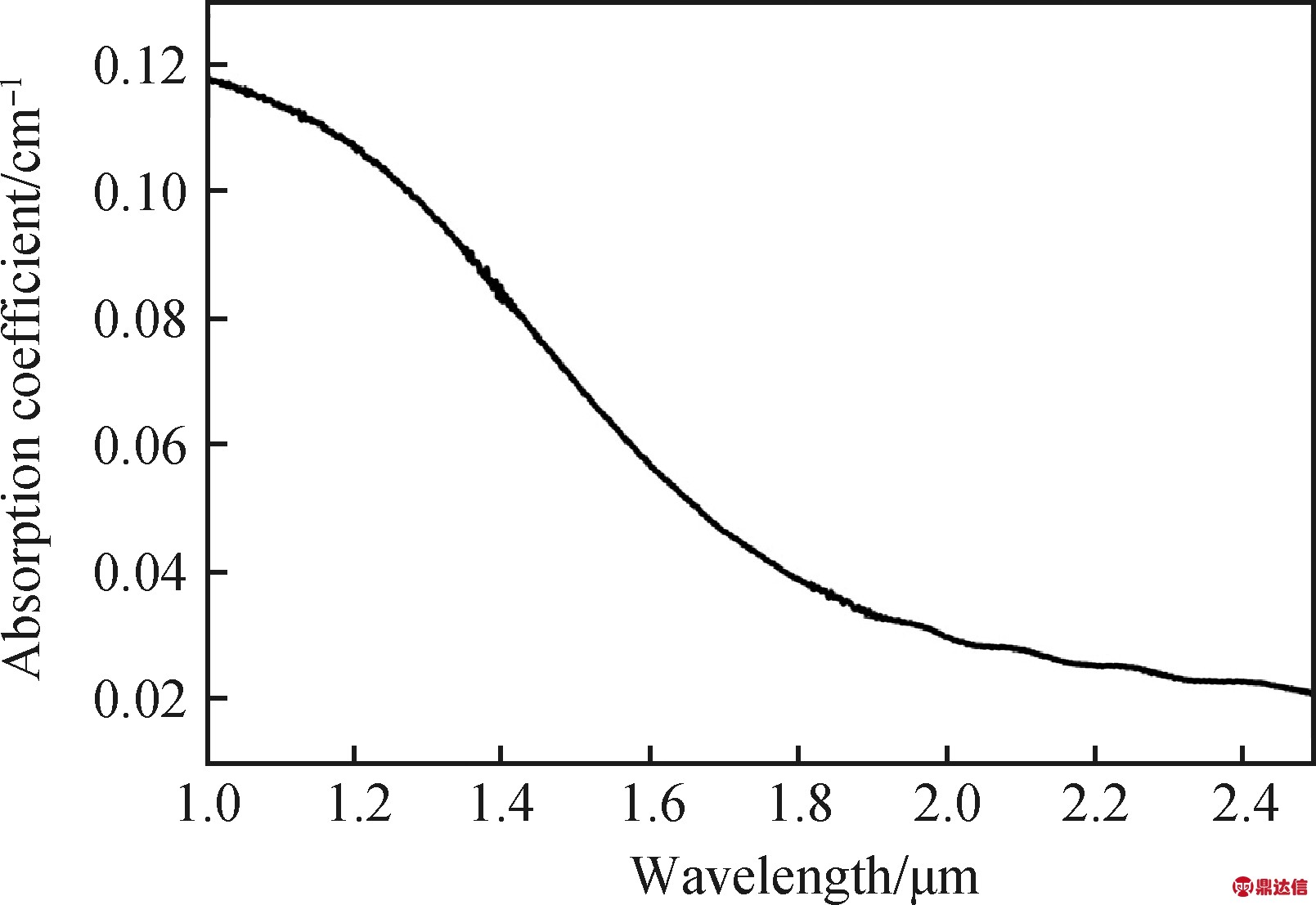
图1 化学计量比生长的ZGP晶体1~2.5 μm吸收谱
Fig.1 1-2.5 μm absorption spectrum of ZGP crystal in stoichiometric ratio

图2 采用间接带隙模型得到的吸收边
Fig.2 The absorption edge obtained by the indirect band gap model
采用Tauc方程来描述带边吸收与光学带隙之间的关系。在吸收边附近,吸收系数可以被展开成:
αE~(E-Eg)γ
(1)
其中α为光学吸收系数,E (1.24 μm·eV/λ)为吸收光子能量,Eg为光学带隙,γ为一个常数。在单电子近似下,γ=1/2,对应直接带隙半导体允许的偶极跃迁;γ=3/2,对应直接带隙半导体禁戒的偶极跃迁;γ=2,对应间接带隙半导体允许的跃迁;γ=3,对应间接带隙半导体禁戒的跃迁。对于ZGP属于间接带隙半导体,在图2中展示了(αE)1/2与E之间的关系,并且在吸收边附近成线性关系。在吸收边附近(αE)1/2与E之间的线性拟合线与E轴的交点为1.85 eV,对应于光学带隙。这个带隙与实验测得的能带带隙约为2.0 eV[5]有细微差别,这是由于激子效应的作用,使得光学带隙会比能带带隙偏小,差值0.15 eV。由此可知,理想ZGP晶体的电子本征吸收和自由激子吸收引起的吸收位能量大于1.85 eV区间,对应的波长小于670 nm(λ<1.24 nm·keV/1.85 eV=670 nm)。通过上述分析可知在2~2.5 μm附近本征吸收对ZGP器件性能无影响。
2.2 GeZn点缺陷晶体的生长
ZGP晶体的光吸收是由于晶体生长过程中引入点缺陷导致的。这些缺陷会在能带中引起缺陷态,在光激发下,电子可能会有缺陷态与价带或导带之间的跃迁,这会导致带边吸收后的缺陷态吸收。同时,缺陷态的引入,会使得电子或空穴与缺陷离子之间形成束缚激子,束缚激子内部的跃迁也会引起光吸收。根据这些缺陷态在带隙中的具体位置以及体系的带电态,这些缺陷态可以作为电子供体或者电子受体。通常化学计量比生长的ZnGeP2晶体中有三种点缺陷:Vp、GeZn以及VZn。据文献报导,在富P的环境对晶体进行退火,能有效遏制Vp缺陷的形成[6]。所以将生长后的晶体进行退火处理,能更好判断GeZn以及VZn缺陷对晶体的影响。通过在富锗环境下合成ZGP多晶料,增加晶体中的GeZn的浓度同时减小VZn浓度,使最终生长的ZGP晶体中点缺陷的种类和浓度得到调控。Ge含量按照表1中偏离理想成分的比例进行合成。1~4号方案单质Ge分别过量1.5at%、1.0at%、0.75at%、0.5at%。经过实验,当Ge过量0.5at%时,能得到较纯的ZGP多晶料,如图3所示。故选用Ge过量0.5at%的配比进行单晶生长。
表1 非化学计量比合方案
Table 1 Non-stoichiometric synthetic scheme


图3 Ge过量0.5at%ZGP多晶料与ZGP标准XRD图谱
Fig.3 XRD patterns of excess 0.5at%Ge ZGP polycrystalline and standard ZGP

图4 Ge过量0.5at%ZGP单晶锭
Fig.4 ZGP crystal of 0.5at% excess Ge
ZGP的熔点为1025 ℃。单晶生长采用垂直布里奇曼下降法。将双温区法合成的ZGP原料加入嵌套在石英管内具有自发成核尖端的PBN坩埚中,抽真空封管。放入下降炉中,控制坩埚底部位置升温至熔点以上20~30 ℃。恒温24 h后,以0.2 mm/h的速度下降至生长完成。生长后的晶体封入装有红磷的石英管中,在双温区内进行退火,退火温度550 ℃,时间为300 h。图4为退火后的过量0.5at%Ge生长的ZGP晶体,晶体质量较好,加工成与标样同尺寸的晶片,使用PerkinElmer Lambda 950对晶片进行2~2.5 μm的红外吸收光谱测试。化学计量比生长的ZGP晶片与过量0.5at%Ge生长ZGP的晶片测试结果分别如图5(a)和5(b)所示。
可以看出图5(a)化学计量比生长的ZGP晶体在2.1 μm、2.25 μm、2.42 μm有3个吸收峰,图5(b)的ZGP晶体只有2.11 μm、2.29 μm 两个吸收峰,而2.4 μm后的吸收峰不明显。富锗环境下合成的ZGP多晶料,增加了晶体中的GeZn的浓度,相应地减小了VZn浓度。GeZn对晶体的吸收产生了更显著的作用,由此初步判断GeZn缺陷是2~2.3 μm产生吸收的主要原因,而2.4 μm以后的吸收峰VZn造成的。为了验证这一结果,结合密度泛函理论计算分析。

图5 化学计量比生长的ZGP晶片(a)与过量0.5at%Ge生长的ZGP晶片(b)2~2.5μm吸收光谱
Fig.5 2-2.5 μm absorption spectrum of ZGP crystal grown in stoichiometric ratio(a) and 0.5at% excess Ge(b)
2.3 第一性原理计算

图6 采用GW方法计算得到的ZGP的能带结构
Fig.6 Band structure calculated by GW method
使用VASP软件包来进行第一性原理计算,其中电子和原子核的相互作用采用投影缀加平面波方法(PAW)。电子相互作用采用PBE广义交换泛函来描述电子交换关联能。对于电子波函数采用平面波展开,平面波的截断能设置为650 eV,高的能量截断值可以用来消除Pulay应力。电子自洽迭代的能量收敛值设置为 10-7eV。先对体系进行结构优化,晶格常数已经原子位置优化直到每个原子的受力都小于0.01 eV/nm。对于本征晶体,采用格林函数(GW)方法计算了体系的能带结构,得到的结果如图6所示。从图可知,ZGP为间接带隙半导体,导带底位于 Σ1与Z之间,准粒子能隙为1.82 eV。为了描述晶体中的缺陷态对 ZGP光学性能的影响,采用超胞方法来模拟GeZn、Vp、VZn缺陷态,采用2×2×2的超胞,超胞包含一个点缺陷。在对缺陷态的结构进行优化达到平衡构型后,采用杂化泛函HSE06来计算体系的电子结构和吸收光谱。其中光学性质的计算,基于独立粒子近似,忽略了激子效应。虽然激子效应对于光学吸收具有重要的影响,但是对于缺陷体系,激子效应的计算量已经超出了现有的计算能力。
介电函数可以展开为如下公式:
ε(ω)=ε(1)(ω)+iε(2)(ω)
(2)
其中介电函数的虚部有带间的直接跃迁贡献,在忽略局部场和有限寿命效应的情况下,采用随机相位近似,根据黄金法则可以得到介电函数的虚部:
(3)
介电函数的实部根据虚部采用Kramers-Kronig关系得到:
(4)
由介电函数,可以得到吸收系数α(ω):
(5)
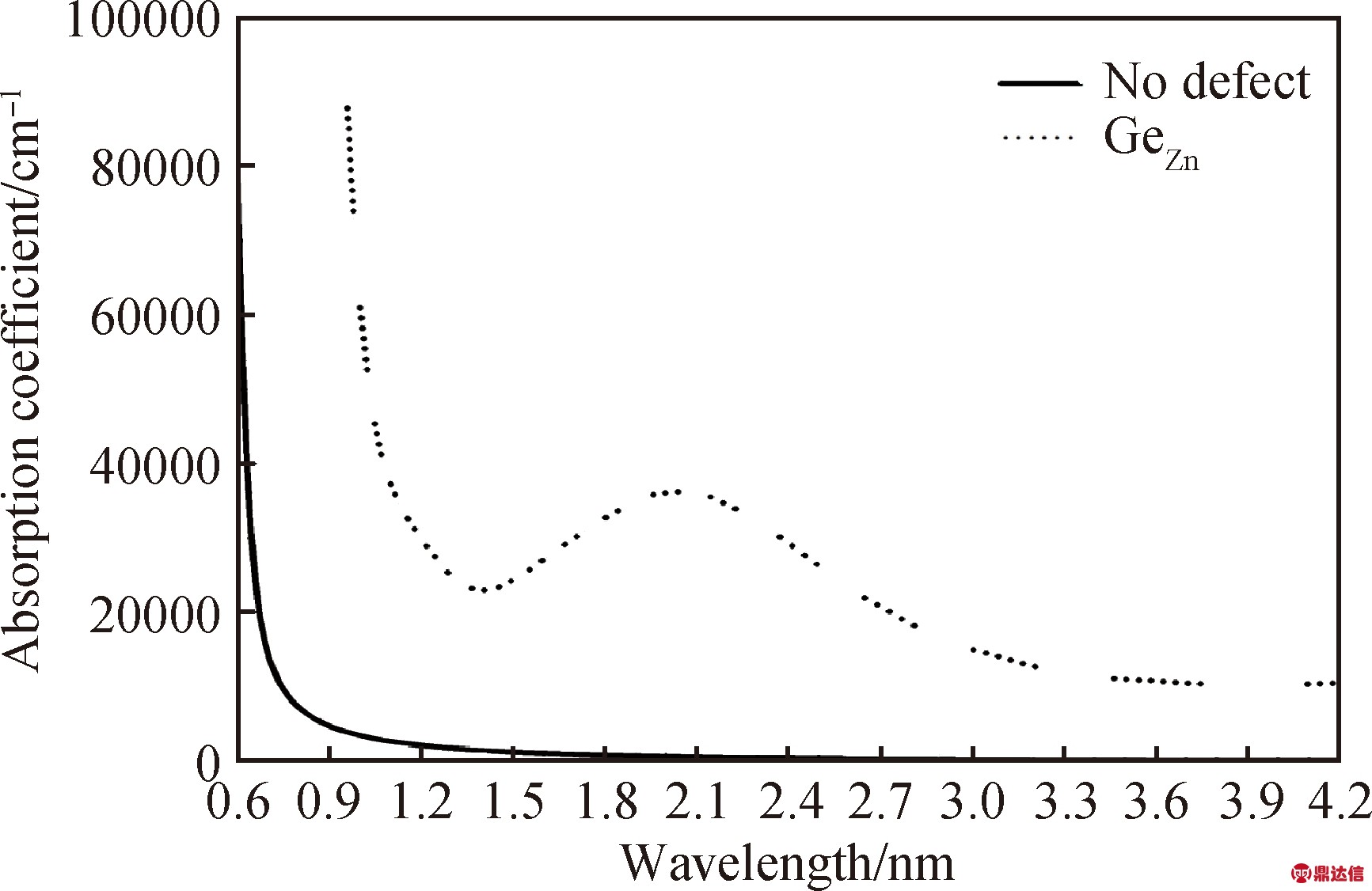
图7 采用HSE06方法计算得到的GeZn 缺陷ZGP晶体的吸收谱图
Fig.7 Absorption spectra of ZGP crystal with GeZn defect calculated by HSE06 method
通过采用上述计算方法,计算得到的GeZn缺陷引起的吸收如图7所示。在不考虑激光照射以及热激发的情况下GeZn缺陷处Ge的4p电子会成为弱束缚态电子,缺陷为中性价态。从图中可以看到GeZn缺陷的存在会在2.1 μm附近引起吸收峰,这与实验观察到的结论一致。
在富Ge条件下生长的ZGP晶体,VP是普遍存在的。对含VP的结构进行优化后,通过第一性原理计算得到的吸收光谱如图8所示。P空位附近有两个Ge原子和Zn原子,在VP存在的情况下,优化得到的结果显示在缺陷周围会发生较大的晶格畸变。VP作为电子供体,其缺陷能级的位置出现在导带底的位置。在不考虑光激发的情况下,缺陷能级为半占据状态,从价带到缺陷能级的跃迁和缺陷能级到导带的电子跃迁都会对光吸收有贡献。由VP引起的吸收峰的强度,相对强度比较弱,其吸收峰的位置主要体现在1.25 μm附近。
对于VZn的存在,其周围的P原子形成的四面体形状维持不变,P原子会向缺陷方向偏移。VZn的存在,会在1.0~1.3 μm以及2.4 μm之后引起吸收峰,如图9所示。其吸收谱的强度与无缺陷晶体的缺陷强度相比相差不大。

图8 采用HSE06方法计算得到的VP 缺陷ZGP晶体的吸收谱图
Fig.8 Absorption spectra of ZGP crystal with VP defect calculated by HSE06 method

图9 采用HSE06方法计算得到的VZn 缺陷ZGP晶体的吸收谱图
Fig.9 Absorption spectra of ZGP crystal with VZn defect calculated by HSE06 method
3 结 论
本文主要针对ZnGeP2晶体在2~2.5 μm范围内的光吸收机理进行研究。采用实验与模拟计算相结合方法,确定了不同的点缺陷产生的不同吸收峰。通过理论计算的方法确定了理想ZGP晶体的电子本征吸收和自由激子吸收引起的吸收位能量大于1.85 eV区间,对应的波长小于670 nm。通过在富Ge条件下生长出大量GeZn点缺陷的ZGP晶体,发现过量0.5at%Ge时,能生长出质量较好的晶体,并在富P的环境下退火,排除了VP的影响,与化学计量比生长的ZGP晶体进行吸收谱对比:结果显示2~2.3 μm的吸收峰主要是GeZn缺陷产生的,2.4 μm以后的吸收峰为VZn点缺陷产生。另外,我们通过密度泛函理论获取缺陷晶体构型,利用VASP软件包来进行第一性原理计算,计算结果与实验相匹配。



