摘要:针对一种MEMS压电式集成打印喷头复杂腔室结构的加工,提出了一套基于ICP刻蚀结合硅硅低温直接键合的制作工艺。首先通过ICP体硅干法刻蚀工艺分别制作了打印喷头的上下腔室结构,然后将带有上下腔室结构的两硅片进行低温直接键合,形成完整的打印喷头腔室。通过对打印喷头上下腔室结构的键合实验研究,进一步探索并验证了硅硅低温直接键合的机理,重点研究了不同活化方法和退火时间对复杂腔室结构键合质量的影响,优化了低温直接键合工艺,为带有复杂三维结构的MEMS器件的制作奠定了工艺基础。测试结果表明,制作完成的MEMS打印喷头具有较高的键合强度,且其腔室流道的完整性和密封性良好。
关键词:MEMS;低温直接键合;硅;活化;界面;打印喷头;加工制造
引 言
喷墨打印技术是指将墨水以一定的速度从微小的喷孔喷射到承印物上,再通过墨水与承印物之间的相互作用实现影像的再现[1]。打印喷头作为微墨滴精准控制的执行单元,是喷墨打印设备中的核心部件。随着MEMS技术的发展及其在喷头上的应用,基于MEMS压电打印喷头的按需喷墨打印已经成为喷墨打印技术的发展趋势,其具有分辨率高、响应迅速、非接触、可靠性强并能够满足多种材质墨水的喷射等优点,在印刷包装、生物医药、印刷电路、光伏制造、三维成形等领域均有着广阔的应用前景[2]。然而国内对MEMS打印喷头的研制还相对落后,相关专利技术长期被国外所垄断,导致国内的喷头产品主要依赖进口,更换成本很高。因此,国内对MEMS压电打印喷头制作工艺的研究就显得尤为重要。
目前,文献报道的MEMS打印喷头所采用的制作工艺主要包括牺牲层法[3-6]和键合法[7-11]。Chung等[3]提出了一种基于牺牲层工艺的腔室制作方法,主要采用SU-8光刻胶加工牺牲层模具,再通过溶解去除牺牲层光刻胶来制作打印喷头腔室;Kim等[11]将分别制作完成的上下腔室结构通过硅硅高温键合工艺组装在一起,形成完整的打印喷头腔室。牺牲层法工艺复杂、制作周期长,且牺牲层难以通过微小的喷孔和流道去除干净;而键合法的退火高温容易对腔室结构造成损害。
因此,本文针对一种MEMS压电式集成打印喷头的复杂腔室结构,提出了一套基于ICP体硅干法刻蚀结合硅硅低温直接键合的制作工艺。主要分为两步:(1)通过ICP体硅干法刻蚀工艺分别制作打印喷头的上下腔室结构;(2)将制作完成的上下腔室硅片进行低温直接键合,形成完整的打印喷头。通过对打印喷头上下腔室结构的键合实验研究,进一步探索并验证硅硅低温直接键合的机理,重点分析不同活化方法和退火时间对键合质量的影响。该工艺能够有效地简化打印喷头的制作流程,同时避免因高温退火对器件结构造成的损害,为带有复杂三维结构的MEMS器件的制作提供可行的工艺参考。
1 打印喷头制作工艺设计
硅材料具有良好的微加工性能和力学性能[12],能够满足打印喷头腔室复杂结构加工和特殊工作环境的要求。硅基MEMS工艺通常采用体硅加工工艺选择性地去除衬底上的材料从而形成特定的三维结构,同时还可以与键合技术相结合以产生更为复杂的器件结构[13]。本文针对一种MEMS压电式集成打印喷头结构(图1),采用基于ICP刻蚀的体硅加工方法结合硅硅低温直接键合技术对其制作工艺进行研究。
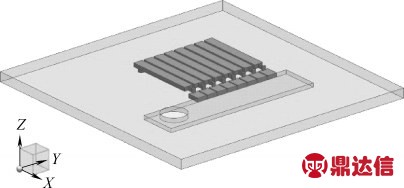
图1 MEMS压电式集成打印喷头结构
Fig.1 Structure of MEMS piezoelectric integrated print head
打印喷头的主要制作工艺流程如图2所示,首先通过正反面光刻工艺将制作好的版图转移至硅片表面,然后采用蒸镀剥离的方法制作干法刻蚀的掩膜,接下来通过ICP刻蚀完成打印喷头上腔室结构的加工;同样地,采用相同的工艺流程对喷头下腔室结构进行加工;最后通过硅硅低温直接键合工艺将分别带有上下腔室结构的硅片进行对准键合,完成打印喷头的制作。刻蚀完成的分别带有上下腔室结构的硅片如图3所示。
2 腔室键合实验
实验采用直径100 mm,n型,100晶向,双面抛光的硅片,其中上腔室采用200 μm厚硅片制作,下腔室采用500 μm厚硅片制作。上下腔室结构采用芯片级低温直接键合,单个打印喷头芯片尺寸为23 mm×23 mm,其键合工艺流程如图4所示。
(1)清洗:分别将带有上下腔室结构的硅片放入盛有丙酮的培养皿中,超声清洗10 min,取出后用去离子水冲洗;再将硅片转移至食人鱼溶液(H2SO4∶H2O2=2∶1)中,90℃水浴加热浸泡20 min,去离子水冲洗;最后将硅片放入RCA-1标准清洗液(NH4OH∶H2O2∶H2O=1∶1∶5)中,65℃水浴浸泡 15 min,取出后用去离子水冲洗并在热板上烘干。
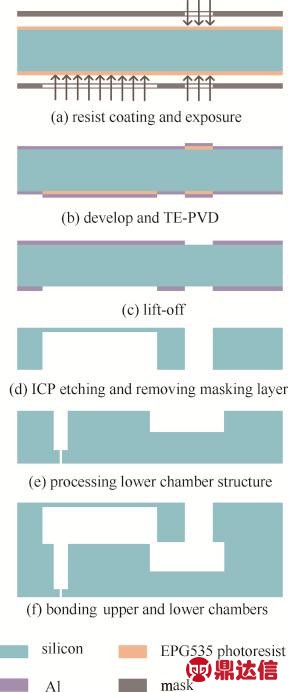
图2 打印喷头制作工艺流程
Fig.2 Print head fabrication process
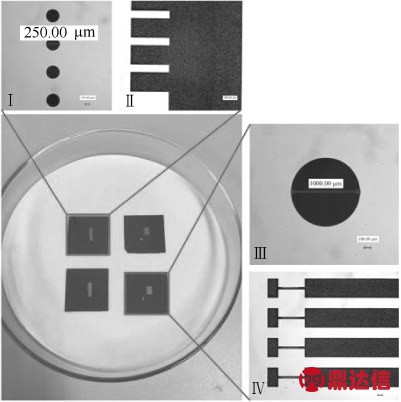
图3 带有上下腔室结构的硅片
Fig.3 Wafers with upper and lower chamber structure
Ⅰ—ink outlet;Ⅱ—lower chamber;Ⅲ—ink inlet;Ⅳ—upper chamber
图4 硅片键合工艺流程
Fig.4 Wafer bonding process
表1 不同活化方法和退火时间的对比实验
Table 1 Comparative experiment of different activation methods and annealing time

(2)活化:为了研究不同活化方法对键合质量的影响,采用对比实验法分别将清洗后的硅片分为两组(组1和组2)进行表面活化处理(具体取样分组和活化条件列在表1中)。首先将两组硅片待键合表面均进行氧等离子体处理(氧气流量60 ml/min,射频功率200 W,工艺时间30 s);紧接着对组2的硅片进行浓氧化性氨溶液(NH4OH∶H2O2∶H2O=6∶1∶3)活化处理,75℃水浴加热浸泡30 min;活化处理完成后将两组硅片用去离子水冲洗并放入盛有去离子水的培养皿中待键合。
(3)预键合:将活化后的分别带有上下腔室结构的硅片在去离子水中进行初步对准贴合组成完整的腔室,用镊子取出并用滤纸将其表面的水分吸除;再使用对准夹具将初步贴合的硅片对进行精确对准,为了使其键合界面的水分能够充分排出,贴合得更加紧密,采用圆柱辊子对其施加50 kg的滚压力[14](50 kgf≈1 MPa,如图5所示);考虑到光刻和ICP刻蚀工艺对待键合表面形貌的影响,同时为了避免较大的键合压力对打印喷头腔室结构造成破坏,最后将贴合的硅片对放在加压平台上施加约3 MPa大小的压力,时长约12 h[15],以完成其预键合过程。

图5 预键合过程中施加的滚压力
Fig.5 Rolling pressure applied during pre-bonding
(4)退火:为了避免退火温度过高对腔室结构和后续PZT压电驱动单元带来不利的影响[16],将预键合后的硅片放入程控烘箱中进行低温退火,退火温度从室温(25℃)匀速升高至140℃,升温速率为1℃/min。采用对比实验法分别对两组不同活化处理的预键合硅片的退火时间进行研究,每组各设置4个样品(表1),退火时间分别为4、6、8、10 h,退火完成后随炉冷却。
最后,通过设计搭建的测试平台对键合完成的打印喷头样片进行一维拉伸实验[图6(a)]和注水测试[图6(b)],对其键合强度和腔室流道的完整性及密封性进行检测。
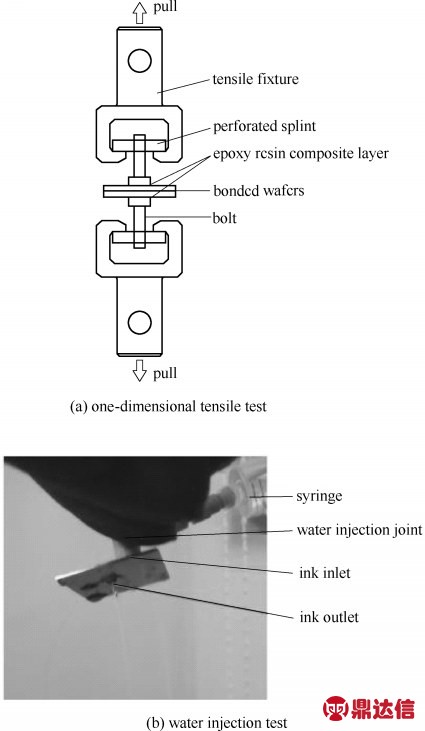
图6 喷头样片键合质量检测
Fig.6 Bonding quality inspection of head samples
3 实验结果与讨论
3.1 键合机理
关于硅硅低温直接键合的机理,Tong等[17-20]和Wang等[21-23]进行了较为深入的研究并建立了相关的理论模型。本文通过对打印喷头上下腔室结构硅片的芯片级低温直接键合实验,进一步探索并验证了硅硅低温直接键合的机理。直接键合对硅片表面质量的要求很高,采用干法刻蚀工艺加工出腔室结构的硅片经过丙酮、食人鱼溶液(H2SO4∶H2O2=2∶1)、RCA-1标准清洗液(NH4OH∶H2O2∶H2O=1∶1∶5)的三重严格清洗后,其表面的污染颗粒和残留有机物及金属等均被清除干净。接着对硅片表面进行活化处理,通过氧等离子体对硅片表面进行高速轰击,使得其表面本征氧化层的Si—O断裂并经过一系列反应形成悬挂的—OH基团[22,24];而浓氧化性氨溶液(NH4OH∶H2O2∶H2O=6∶1∶3)处理时,氨水能够与硅片表面的本征氧化层发生反应,使得硅片表面附近的Si—O断裂并形成Si—OH,同时双氧水在其分解的过程中提供了大量自由的—OH基团,将更有助于硅片表面产生高浓度的—OH基团,从而使硅片表面具有较高的活化能[17,25-26]。两种活化方法均是在硅片表面形成—OH基团,再经过退火过程发生缩合反应脱水产生Si—O—Si共价键,从而使得两硅片紧密地结合在一起,其反应方程式为
通过对硅片表面进行亲水性检测,间接验证了其表面—OH基团的浓度[27-29],实验结果显示,氧等离子体活化处理后的硅片表面的接触角为56°,浓氧化性氨溶液处理后的表面接触角为25°,而两者结合活化后的硅片表面接触角为4°。这就说明了本文结合氧等离子体和浓氧化性氨溶液两种活化处理的方法,能够使硅片表面悬挂—OH基团的浓度大大增加。通过将两活化完成的硅片在水中进行对准贴合,有效地避免了人为操作和实验环境对键合界面可能造成的二次污染;同时,水中贴合使得硅片表面的Si—OH键与水分子结合,通过滚压排出键合界面多余的水分,两硅片在表面水分子氢键的作用下更容易紧密地贴合,以完成预键合过程。
3.2 不同活化方法对键合质量的影响
首先分别对两组实验中各键合样片进行注水测试,结果显示,除组1中样片A出现了漏水现象外,其余各样片均测试成功,每个喷孔均有连续均匀的水流喷出,键合强度达到测试要求,腔室流道连通完整且密封性良好。接着对各键合样片进行一维拉伸实验,测得的键合强度如图7所示。从图可以看出,相同退火条件下组2中各样片的键合强度均明显高于组1。退火8 h和10 h时组2中样片G和样片H拉断后的键合界面分别如图8(a)、(b)所示,均出现了体硅断裂的现象,其中样片G的键合强度达到最高的3.86 MPa。这就说明氧等离子体结合浓氧化性氨溶液的活化处理方法能够显著提高硅片表面—OH基团的浓度,进而发生缩合反应形成更多的Si—O—Si共价键,使得两硅片的键合强度明显提高。

图7 不同活化方法和退火时间对键合强度的影响
Fig.7 Effect of different activation methods and annealing time on bonding strength
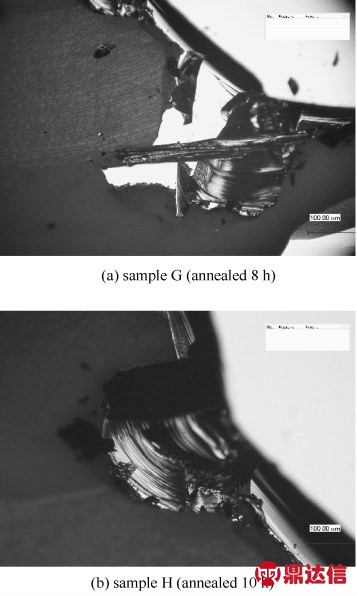
图8 拉断后的样片键合界面局部
Fig.8 Part of sample bonding interface after breaking
3.3 不同退火时间对键合质量的影响
由图7可知,两组样片在140℃的温度下进行退火时,当退火时间从4 h增长到8 h的过程中,键合强度均随着退火时间的变化而快速增长;当退火时间超过8 h后,组1中样片的键合强度增长明显放缓,组2中样片的键合强度略微减小。这是因为两硅片键合界面在退火过程中发生的缩合反应是可逆的,当退火温度一定,缩合反应达到平衡时的反应程度也是一定的。当退火时间较短时,缩合反应向正向不断进行,形成的Si—O—Si共价键不断增多,键合强度快速提高;当退火时间较长,反应趋于平衡后,随着时间的增长键合强度也趋于稳定;而当退火时间过长时,因上下硅片所带腔室结构的差异,使得其内部产生的变形能高于键合能,从而造成键合强度的下降[23]。
4 结 论
针对一种MEMS压电式集成打印喷头复杂腔室结构的加工,提出了一套基于ICP刻蚀结合硅硅低温直接键合的制作工艺。实验结果表明,制作完成的MEMS打印喷头具有较高的键合强度,且其腔室流道的完整性和密封性良好。同时,通过对打印喷头上下腔室结构硅片的芯片级低温直接键合实验的研究,进一步得出以下结论。
(1)实现了带有复杂结构的硅片的低温直接键合,键合强度高达3.86 MPa,远大于数值模拟的喷墨过程中腔室内部的最大瞬时应力0.64 MPa,能够满足打印喷头特殊工作环境的要求。与采用聚合物材料键合制作的腔室相比[30],本文所用的硅材料加工工艺成熟,且能够有效避免聚合物腔室易坍塌的问题,同时键合强度明显较高;与采用硅硅高温键合制作的打印喷头腔室相比[11],本文采用低温硅硅直接键合的方法,有效避免了因退火高温产生过大的热应力对器件结构造成损害,同时低温直接键合的方法工艺简单,对设备要求低,成本低廉,为带有复杂三维结构的MEMS器件的制作奠定了工艺基础。
(2)通过将两活化完成的硅片在水中进行对准贴合,有效地避免了人为操作和实验环境对键合界面可能造成的二次污染,为普通洁净室条件下的晶片直接键合提供了可行的途径。
(3)水中贴合使得硅片表面的Si—OH与水分子结合,通过滚压排出键合界面多余的水分,两硅片在表面水分子氢键的作用下更容易紧密地贴合,从而完成预键合过程,为键合质量的提高产生有利的影响。
(4)氧等离子体结合浓氧化性氨溶液的活化处理方法能够显著提高硅片表面—OH基团的浓度,进而发生缩合反应形成更多的Si—O—Si共价键,从而使得两硅片的键合强度明显提高。



