摘 要:基于正交试验法研究不同温度与振动耦合条件下的板级焊点失效行为与模式,采用L9(34)混合水平正交表设计了不同温度(T)、加速度功率谱密度(PSD)与频率(V)条件下的加速寿命试验,结果表明三者对焊点可靠性影响程度为T>PSD>V,且温度是影响焊点失效模式的主要因素,随温度的升高,焊点裂纹逐渐从近封装侧的界面金属化合物(IMC)层向钎体内部扩展,焊点失效模式从脆性断裂向韧性断裂演化.基于焊点失效数据分析,发现焊点疲劳寿命对数值与PCB板背侧最大应变范围存在关联关系,并采用多项式拟合的方法建立了焊点疲劳寿命模型,拟合结果显示,该模型能较好的评估温度与振动耦合条件下的焊点寿命,预测精度较高.
关键词:温度与振动耦合;焊点;失效模式;疲劳寿命
1 引言
在电子设备中,电子芯片通过焊点实现与电路板之间的机械固定与电气互联.随着电子制造技术的进步,焊点尺寸越来越小,密度越来越高,电子设备的服役环境却越来越严酷,尤其是在航空航天与军事领域,机载或弹载电子设备通常工作在高、低温频繁转换与振动等恶劣环境中,板级焊点在外界载荷的作用下会产生应力应变,而应力集中的部分极易出现裂纹萌生,裂纹扩展,以至于整个焊点完全断裂,进而导致电路板开路,电子设备故障或失效,因此板级焊点是影响电子设备可靠性的关键环节,其疲劳寿命很大程度决定着整个电子设备的寿命[1~3].
美国空军航空电子分析中心的统计数据显示,温度和振动是导致电子设备故障的主要环境因素,由温度和振动引起的电子设备失效高达75%.因此,国内外众多研究集中在温度或振动载荷下焊点的可靠性[4~7].但是,在实际服役环境中,焊点产生损伤并不只是一种单纯应力诱发的,而是周围多种环境应力的叠加的结果.相比于单一应力,在多种应力耦合作用下,焊点的失效模式可能会由于外部多种环境应力产生的交互作用而发生变化.而由于复合加载试验的复杂性等原因,关于多场耦合条件下的焊点可靠性问题研究却十分有限.UPADHYAYULA K和DASGUPTA A [8]最早基于损伤增量叠加法研究了温度循环与冲击振动复合加载情况下的焊点可靠性问题,结果表明复合加载对焊点造成的损伤小于室温条件下单纯振动造成的损伤,但是这种线性叠加的方法忽略了温度与振动载荷之间的相互作用.王欢等人[9]根据线性叠加法对复合加载下的焊点寿命进行了数值模拟,但并没有相关试验结果的支持.KIM Y K等人[10]对BGA焊点进行了随机振动与温度循环的顺序加载试验,结果发现焊点经过随机振动试验后再进行温度循环试验并不会对焊点造成额外损伤.YING D等人[11]研究了CCGA(Ceramic Column Grid Array)焊点在依次经历正弦振动、随机振动、温度循环载荷试验后的可靠性,得出机械振动是导致焊点裂纹产生的主要原因,通过加固PCB板可以提高焊点的可靠性.张波等人[12]研究了热周期与跌落冲击顺序载荷下的板级无铅焊点的可靠性,即首先进行温度循环试验,然后进行跌落冲击试验,结果表明少量的温度循环试验后焊点的跌落寿命反而延长了,而过量的温度循环载荷会使焊点寿命缩短.文献[10~12]的顺序试验法是基于不同载荷之间不存在序列效应为前提的,在实际服役环境中,焊点失效是温度与振动同时作用的结果,焊点在耦合作用下的失效机理与模式和先后经历热周期与机械载荷的失效机理与模式可能会有较大不同.QI H和OSTERMAN M等人[13]的利用平均应力叠加的方法研究了温度循环与随机振动复合加载情况下的焊点可靠性问题,结果表明与单纯振动或者热循环载荷相比,焊点在振动和热循环复合加载情况下更以出现损伤,使用寿命更短.ZHANG H W等人[14]研究了不同温度条件下的焊点振动可靠性问题,结果显示与单纯振动载荷相比,焊点的振动寿命会随着温度的提高而延长.文献[13]和文献[14]的结论又是相矛盾的.
由此可见,目前温度与振动耦合条件下的焊点失效机理尚不明确,对于温度和振动的耦合作用对焊点疲劳寿命产生的影响认识不足.因此本文基于正交试验的方法设计了不同温度与振动耦合条件下的焊点加速寿命试验,分析振动和振动两种外部载荷因素对焊点可靠性带来的影响,揭示焊点在在不同温度与振动耦合作用下的失效模式,并基于多项式拟合建立了焊点疲劳寿命模型,用以评估焊点寿命.
2 温度与振动耦合条件下板级封装疲劳失效试验设计
2.1 BGA焊点加速寿命试验
试验选用的是在电子设备中常见的球栅阵列(Ball Grid Array,BGA)式封装器件,试验电路板如图1所示.封装中焊点所用钎料为Sn3.0Ag0.5Cu(SAC305),印刷电路板为镀Ni/Au层的FR-4基板,焊盘选用常见的Au/Ni/Cu结构镀层焊盘.器件尺寸参数如表1所示.

表1 BGA器件尺寸表

与单一载荷加速寿命试验相比,复合加载条件下的加速寿命试验对试验环境和信号采集等条件要求比较高.分别通过振动台和温箱搭建振动环境和温度环境,设计过渡轴和软膜联接实现振动台和温箱的组装配合,从而完成振动、温度环境的协同复合加载,如图2所示.试验中,将BGA封装形成的菊花链,通过订制MI-7016型16通道数据采集仪构建菊花链监测系统,实现对PCB板的动态应变信号与焊点的电压信号的同步实时监测.当菊花链电阻值增大10倍以上,且持续时间大于1s,则判断封装完全失效.
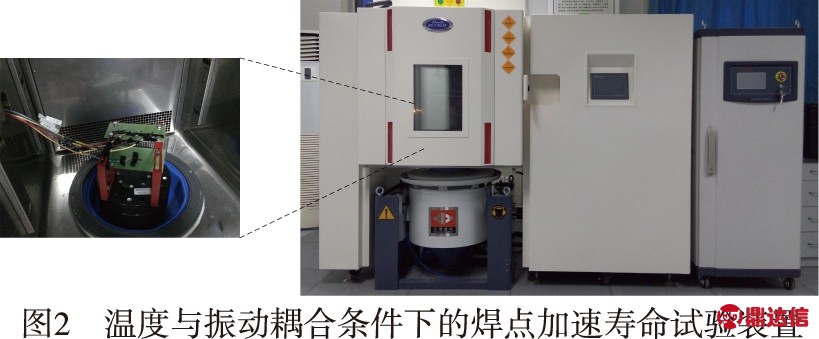
2.2 正交试验方案设计
正交试验设计是利用正交表科学研究多因素多水平的一种设计方法,基于一定的规则设计正交表,确保以最小数目的实验获得全因子实验中影响性能参数的全部信息[15].采用正交实试验设计的方案实施温度与振动耦合条件下的BGA焊点可靠性试验,可在获取影响焊点可靠性因素的同时,减少试验次数和成本.
在实际服役环境下,焊点所承受的外部载荷会因电子设备所处的工作环境严酷程度不同而有所差异.根据美国ML-STD-883标准,焊点工作环境的温度范围大多在-40℃~125℃区间,可以按温度值(T)的不同将温度载荷划分为三个梯度:低温(<0℃)、室温(0~65℃)和高温载荷(>65℃);而振动载荷则主要由振动频率(V)和加速度功率谱密度(PSD)来表征,按照频率与功率谱密度的不同也可分为低、中、高三种量级.焊点的工作环境通常是不同的温度梯度与不同的振动量级同时存在,两者相互作用形成了耦合载荷.例如,高温与低频、低PSD值耦合的载荷,室温与中频、低PSD值耦合的载荷等.因此,试验选取能够表征温度载荷与振动载荷严酷程度的温度值(T)、加速度功率谱密度(PSD)与频率(V)为因素设计正交试验,表征各温度梯度与各振动量级的因素水平如表2所示.
表2 BGA测试样件的正交试验因素水平表
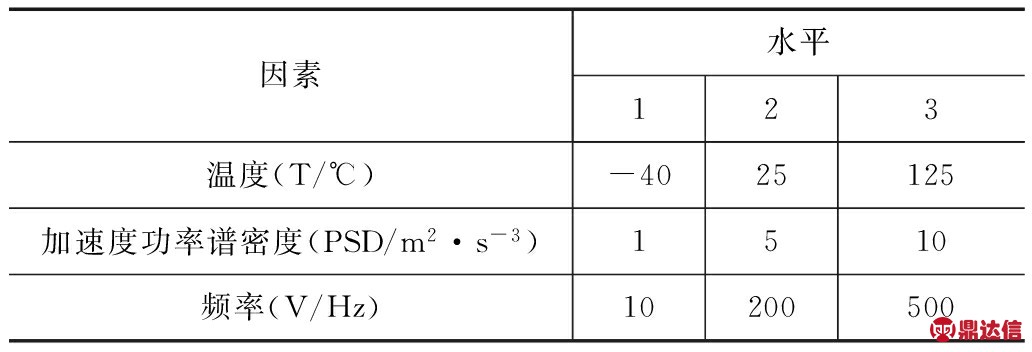
根据确定的因素及水平,选用L9(34)混合水平正交表,如表3所示.而如果做完备的耦合试验,至少需要3×3×3=27组试验,显然大大减少了试验次数.根据试验方案的组合数目,试验所需的测试样件至少为9件.在本试验中,考虑重复性试验样本,每种组合载荷条件下A测试样件为5件,因此,测试样件总数为45件.
表3 正交试验方案

3 试验结果分析与讨论
3.1 试验结果及极差分析
正交试验的极差分析法又称为直观分析法,通过分析极差的大小评价各因素对试验指标的影响程度.极差越大,表示这个因素的数值在试验范围内变化时,导致试验结果的变化越大,所以极差最大的那个因素是主要因素.
经过各种应力水平组合条件下的加速寿命试验,BGA测试样件的疲劳寿命结果如表4所示,其中的空列为考虑误差分析而设.Ki表示任一列中水平为i所对应的试验结果之和,ki为Ki的算术均值,即ki=Ki/ni,ni为任一列中i水平出现的次数.极差R=max(ki)-min(ki).
通过极差分析结果可以看出,温度因素的极差值最大,表明温度对焊点可靠性的影响最大,加速度功率谱密度次之,频率最小.由试验的计算结果可以进一步得出焊点疲劳寿命随试验因素的变化趋势图,如图3所示.当温度下降时,焊点的可靠性在低温条件下的疲劳寿命会显著下降,这表明低温是影响焊点可靠性的关键因素;在加速度功率谱密度增大时,焊点的寿命也会明显下降,这表明当振动能量增加时,焊点的可靠性降低;此外,可以发现当频率为200Hz时焊点的寿命值较短,通过对测试组件进行模态分析发现,其一阶频率为234Hz,靠近一阶频率的振动容易引起PCB板的共振,电子组件基板和PCB板都会产生较大的弯曲变形,焊点承受的交变应力增大,从而导致寿命值缩短.
表4 正交试验结果

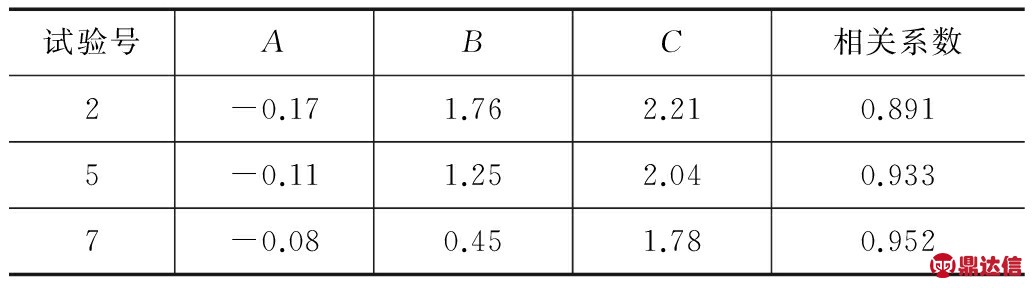
3.2 方差分析
正交试验的方差分析是将试验数据的总离差平方和分解为各因素的离差平方和与试验误差平方和之和,基于各因素的离差平方和与试验误差平方和构造检验统计量,作F检验来判断各因素对试验结果的作用是否显著.
根据有重复试验的正交试验数据方差分析理论,计算各因素的离差平方和Qi及对应的自由度fi:
(1)
fi=zi-1
(2)
式中:n为试验组数;t为每组试验的重复次数; mi为表中第i列所安排因素的水平重复次数;zi为第i列所安排因素的水平数;Yij为在第i个因素的第j个水平下所做的试验结果之和,即mi·t组试验结果之和;yvu(v∈[1,n],u∈[1,t])为每次试验结果.
试验误差平方和QE及对应的自由度fE:
(3)
(4)
式中![]() 为空白列的离差平方和,按照式(1)计算.
为空白列的离差平方和,按照式(1)计算.![]() 为空白列离差平方和对应的自由度,按照式(2)计算.
为空白列离差平方和对应的自由度,按照式(2)计算.
各因素的方差估计值![]() 及试验误差的方差估计值
及试验误差的方差估计值![]()
(5)
(6)
定义各因素对应的检验统计量Fi:
Fi=![]()
(7)
根据F分布检验原理,当F0.05(fi,fE)≤Fi<F0.01(fi,fE)时,判断i因素为显著性因素(置信度p=95%),记为“**”;当Fi>F0.01(fi,fE)时,判断i因素为高度显著性因素(置信度p=99%),记为“***”;当Fi<F0.1(fi,fE)时,判断i因素为非显著性因素(置信度p=90%).
根据上述公式,各因素的方差分析结果如表5所示.
由表4可知,FT>F0.01(2,2),说明温度对焊点可靠性的影响高度显著(置信度p=99%); F0.05(2,2)<FPSD<F0.01(2,2),F0.05(2,2)<FV<F0.01(2,2),说明加速度PSD值与频率对焊点可靠性影响显著(p=95%).各因素对焊点可靠性影响显著性排序为T>PSD>V,这与极差分析的结果是一致的.
表5 方差分析表

3.3 BGA 失效模式分析
焊点的疲劳寿命与其失效模式是紧密相关的,不同的失效模式必然导致疲劳寿命的差异.根据3.1节与3.2节分析,温度是影响焊点可靠性最为显著的因素,焊点的失效模式也应与温度载荷密切相关,因此,本文基于温度T因素,将所做的试验件按照温度载荷(-40℃,25℃,125℃)的不同划为三类,对不同温度条件下的焊点进行金相分析,观察裂纹的扩展方式,并统计各种失效模式所占比例,以确定在该温度条件下的焊点主要失效模式.
根据金相分析的结果,焊点的失效模式主要有3种,如图4所示.对不同温度条件下焊点失效模式所占比例进行统计分析,如图5所示.在低温条件下,焊点的主要失效模式为图4(a),即裂纹沿近封装侧的IMC层萌生与扩展;在室温条件下,焊点的主要失效模式也为图4(a),但值得注意的是,失效模式图4(b)所占的比例大幅上升,即裂纹在IMC层萌生并开始逐渐向钎体扩展,这属于一种混合式裂纹;在高温条件下,焊点的主要失效模式为图4(c),即焊点的裂纹出现在近封装侧的钎体内.
通过试验结果分析,焊点处于低温环境时,应力主要集中在近封装侧的IMC层,这与前期有限元分析的结果是一致的,如图6所示.此时焊点的脆性较大,因此表现为IMC层的脆性断裂.当环境温度升高时,焊点的屈服应力与弹性模量降低,导致焊点的塑性有所提高,近封装侧的IMC界面应力有一部分被钎体吸收,因此裂纹在IMC层萌生,逐渐开始向钎体扩展,表现为脆性断裂与韧性断裂的混合模式.当周围环境温度很高时,焊点主要表现为塑性,因此裂纹开始出现在钎体内,表现为韧性断裂.
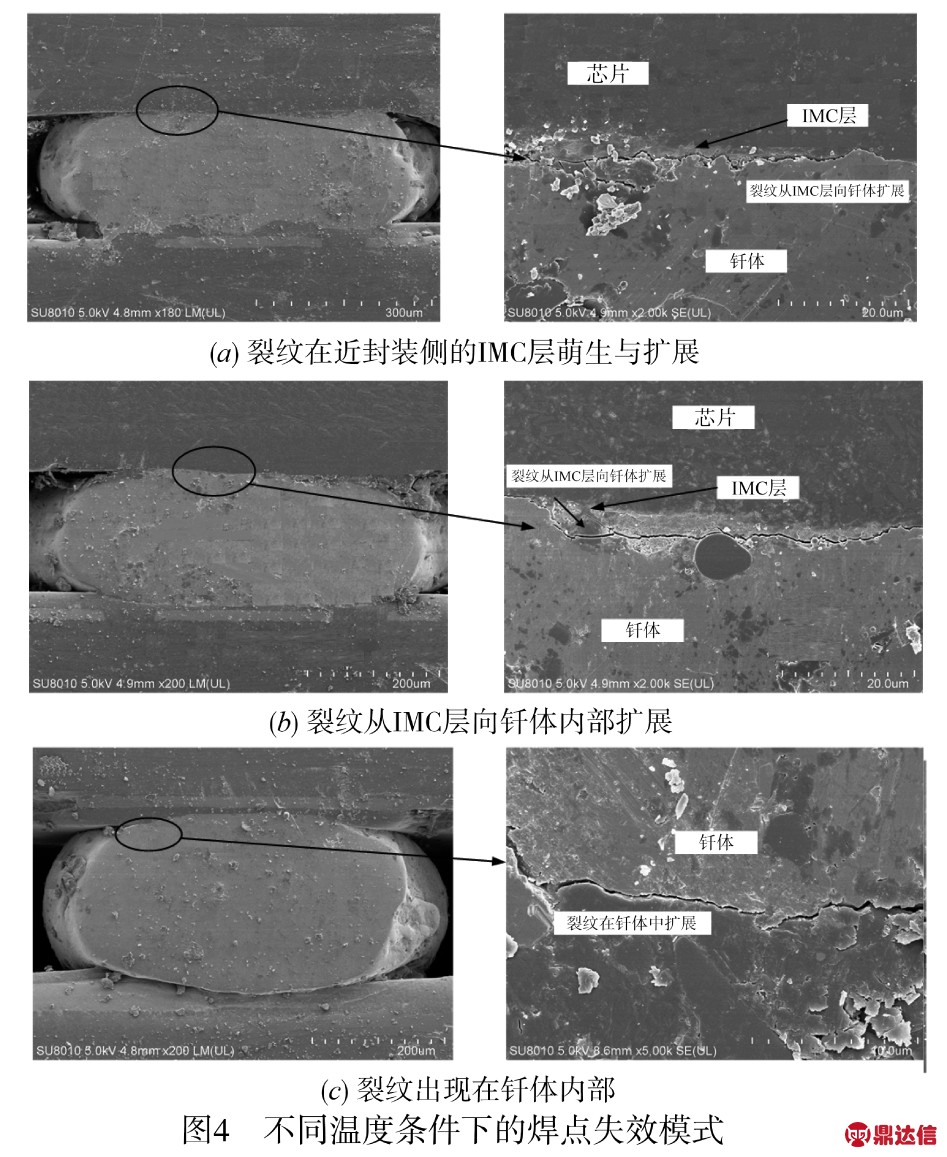
同时,值得注意的是,振动载荷对焊点失效进程的影响也是不可忽视的.与单一的温度时效试验结果相比,振动载荷的存在会加速焊点的失效进程,尤其在低温条件下,接近固有频率的高PSD值振动载荷会使焊点很快出现裂纹,并且脆性断裂所占失效模式的比例明显提高.究其原因,在往复振动载荷下,电子芯片基板和PCB板都会产生挠曲变形,从而在焊点中形成交变应力,这种应力形式表现为拉力或压力.而在低温的情况下,焊点主要表现为脆性,因此当振动量级较高时,在焊点中产生的较大拉/压力会加速裂纹萌生进程,并且表现为直接贯穿IMC层的脆性断裂.


4 基于多项式拟合的焊点疲劳寿命分析
通过第3节中的分析可知,当焊点在低温、高PSD值、振动频率接近PCB板的固有频率时,其疲劳寿命明显降低,特别是当三者叠加时,焊点疲劳寿命值降至最低点.这说明温度与振动之间存在耦合作用,且这种作用会加速焊点疲劳失效.在前期的研究中[16],已经发现PCB板背侧的应变信息包含了封装中的潜在故障信息,以试验2、5、7为例,图7给出了在三种不同试验条件下焊点寿命的对数值随PCB板背侧应变范围的变化曲线,如3.3节所述,在低温条件下焊点呈现出硬化特性,随温度升高焊点的塑性逐渐提高,可以看出其寿命对数值-应变范围曲线接近于二次多项式,因此基于数据驱动的思想,采用多项式拟合的方法对板级封装应变与焊点寿命的关系进行拟合,建立焊点的疲劳寿命模型.

4.1 寿命模型的建立
由于焊点寿命的对数值与应变范围接近于二次多项式,因此采用式(8)进行拟合,拟合参数如表6所示.
Δε=f(lgN) =A(lgN)2+BlgN+C
(8)
式中,Δε为应变范围,lgN为焊点寿命的对数值,A、B、C代表为二次多项式的系数.
表6 拟合参数表
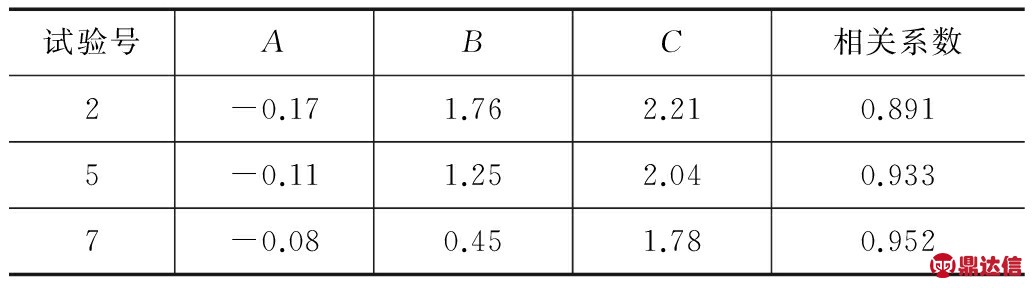
焊点在三种试验条件下的寿命方程为
Δε=-0.17(lgN)2+1.76lgN+2.21
Δε=-0.11(lgN)2+1.25lgN+2.04
Δε=-0.08(lgN)2+0.45lgN+1.78
(9)
对式(8)做进一步变换可得焊点的寿命模型.
(10)

(11)
式中,lgNcentre=-![]() ,Δεmax=
,Δεmax=![]() .(lgNcentre,Δεmax)代表寿命曲线方程中的中心点,Δεmax为焊点能达到的最大应变范围,而lgNf为焊点的疲劳寿命对数值,此时的应变范围Δεfinal较最高点有所下降,如图8所示,在实际服役环境中,可以根据实时监测的PCB板的应变数据,基于式(11)拟合出焊点的寿命模型,并依据历史数据量对寿命方程中的参数进行适时修正,即可实现对焊点寿命的评估与预测.
.(lgNcentre,Δεmax)代表寿命曲线方程中的中心点,Δεmax为焊点能达到的最大应变范围,而lgNf为焊点的疲劳寿命对数值,此时的应变范围Δεfinal较最高点有所下降,如图8所示,在实际服役环境中,可以根据实时监测的PCB板的应变数据,基于式(11)拟合出焊点的寿命模型,并依据历史数据量对寿命方程中的参数进行适时修正,即可实现对焊点寿命的评估与预测.

4.2 寿命预测结果分析
将第7组试验的另外4组试验数据作为输入,对焊点的寿命方程进行检验.图9为不同时刻的寿命预测结果.可以看出除了个别点外,大部分寿命预测点都处于±10%误差带中.另外,通过低温和高温的寿命曲线对比,发现在温度较高时,焊点在失效前的应变范围会有所下降,这应与焊点的塑性有关.当外界温度增高时,焊点的塑性随之提高,随着时间的积累,焊点的蠕变损伤逐渐演变成焊点失效的主因,并且焊点在失效前出现了应力松弛,而在低温条件下则没有这一现象.

5 结论
基于正交试验法研究了不同温度与振动耦合条件下的焊点失效模式,分析了温度与振动因素对焊点可靠性的影响程度.基于多项式拟合的方法建立了焊点疲劳寿命模型.通过试验分析与验证,得到以下结论:
(1)温度与振动之间存在耦合作用,且这种作用会加速焊点疲劳失效.温度(T)、振动加速度功率谱密度值(PSD)与振动频率(V)对焊点可靠性影响程度排序为T>PSD>V.
(2)随着温度的升高,焊点的塑性提高,焊点的裂纹逐渐从近封装侧的IMC层向钎体内部扩展,导致焊点的失效模式从脆性断裂向韧性断裂演化.
(3)焊点的疲劳寿命对数值与PCB板背侧最大应变范围存在关联关系,基于多项式拟合的方法可以实现对两者关系的度量,在实际服役环境中,可以根据实时监测的PCB板的应变数据,实现对焊点寿命的评估与预测.



