摘 要:单粒子效应易诱发空间电子设备发生在轨故障。文章针对大容量NAND Flash存储器,利用皮秒脉冲激光和高能重离子开展了试验研究,明确了此类器件的单粒子效应特点,探索了新型集成电路单粒子效应试验评估方法,为工程设计及试验评估提供了技术基础与保障。经皮秒脉冲激光试验发现,NAND Flash存储器件的存储单元易发生单粒子多位翻转,控制电路单元则发生单粒子锁定和功能中断。 经高LET值Xe+离子辐照试验发现,重离子会诱发器件产生电流尖峰脉冲(或电流火花)现象;在NAND Flash存储器未加电状态下,仍可诱发单粒子翻转;重离子辐照后存储器坏块明显增加,试验获得的单粒子翻转截面高达1.18×10-7cm2/位。基于试验结果分析,认为发生多位翻转的原因是激光束覆盖多个存储单元所造成;重离子辐照引起的浮栅晶体管击穿是存储器坏块增多的原因。
关键词:单粒子效应;NAND 闪存;脉冲激光;重离子
0 引言
近年来,新型器件的单粒子效应严重影响了我国多颗卫星不间断稳定服务的要求及效能的发挥,卫星任务迫切需要解决单粒子效应的影响问题。在未来很长时间内,我国卫星依然不得不选用具有单粒子效应高敏感度的新型商业器件,如大容量存储器、微处理器件等,使得今后卫星依然面临着单粒子效应影响的严重挑战。而以往的辐射效应评价方法、防护设计验证方法,有的不能覆盖新型器件,有的对于新型器件不能适用,这对卫星设计研制、功能实现、使命达成等构成了技术制约与障碍。在开展航天器电子系统设计时,迫切需要新型器件单粒子效应机理、试验评价、防护设计验证等方面的技术支撑,因而,对大容量NAND Flash(闪存)存储器单粒子效应[1-7]的试验研究具有十分重要的意义。鉴于此,本项工作针对大容量闪存存储器,结合实验室脉冲激光单粒子效应试验系统和国内重离子加速器试验设备,开展了单粒子效应试验研究,探索了新型电子器件和集成电路单粒子效应试验评估方法,以期为工程设计及试验研究工作提供技术基础与保障。
1 试验样品简介
NAND Flash存储器是一种长寿命的非易失性存储器,即在断电情况下仍能保持所存储数据信息的存储器,在航天器电子设备设计中,常用来构建大容量数据存储装置。NAND Flash存储单元的基本结构如图1所示。它有两个栅:一个控制栅和一个位于沟道和控制栅之间的浮栅,其结构类似于EEPROM。但沟道和浮栅之间的氧化层更薄,电子可以通过F-N隧道效应或热电子注入机制在浮栅和源区或沟道之间传输。根据浮栅的带电状态,存储单元成为耗尽型或增强型的晶体管。在控制栅上施加一定电压,晶体管就处于截止和导通状态,对应于存储信息“0”或“1”。一般情况下,闪存存储器在写入信息前,浮栅上无电子,晶体管导通,表示存“1”。写入信息的过程就是使电子注入浮栅,晶体管截止,表示存“0”。为了减少读写时间,实现电擦除和电编程特性,大部分闪存存储器还有命令状态器和写状态器等控制单元。
由于NAND Flash存储器复杂的内部结构和制作工艺,由脉冲激光和重离子诱发的辐射效应机理尚在进一步研究中。国内外相关试验研究工作结果表明[8-12],在空间辐射环境中,重离子击打在NAND Flash存储器上会在浮栅和周围的绝缘层内电离产生电子空穴对;电子空穴对在电场的作用下漂移,在界面处形成界面陷阱电荷,使晶体管的阈值电压向负方向漂移。有可能使原来截止的晶体管导通,导致存储单元的状态发生变化,出现单粒子翻转。另外,NAND Flash存储器的擦除操作是靠内部高压产生器产生的高电压,辐照有可能使内部电荷泵遭到破坏,以至于不能擦除[11]。在擦除和编程过程中有可能发生单粒子功能中断(SEFI)和单粒子锁定(SEL)等破毁性单粒子效应,本实验研究也观察到了上述单粒子现象。
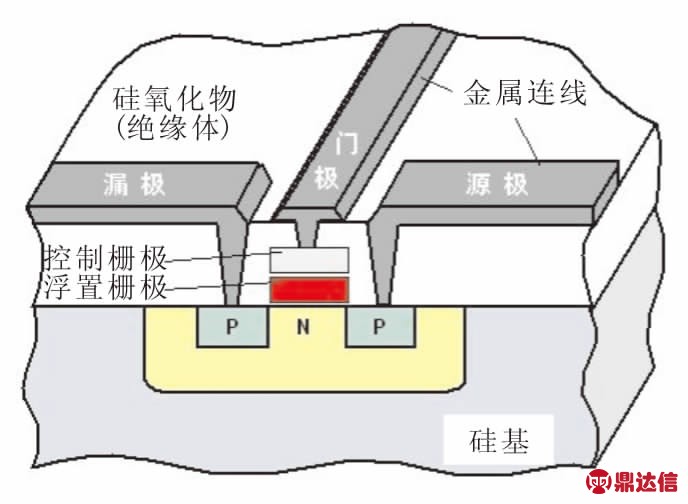
图1 闪存存储器单元示意图
Fig.1 Unit Diagram of NAND Flash Memories
2 试验过程及方法
2.1 试验设备
实验室激光模拟单粒子效应试验系统[13-17]是将两种激光器和四种波长集中在同一套模拟试验系统上,系统主要由激光器系统(纳秒级激光器,波长:1079nm/540nm、脉宽:9ns~12ns;皮秒级激光器,波长:1064nm/532nm、脉宽:20ps~30ps)、聚焦定位系统(聚焦定位平台可三维调节,最小移动步长为:1.25μm;聚焦光斑直径为2μm~5μm)、控制和测试系统单元等组成。
重离子试验设备为中国科学院近代物理研究所的HIRL加速器;试验终端主要由束流终端室、离子光学系统、束流测量及定位系统、控制和测试系统等组成。
依据试验设备工作情况,选取重离子为Xe+离子,离子的每核子能量为19.5MeV,通过衰变器对离子能量的衰减,离子到达器件表面的能量约为840.0 MeV,离子的LET值为65.60MeV·cm2/mg,离子在硅材料中的射程为62.8μm。
试验样品为三星公司制造的商用大容量NAND Flash存储器,每4个试验样品构成一块测试板,测试板与下位机测控设备之间的电缆长度是30米,试验现场能满足上述两台电子产品的连接要求,并根据需要,对下位机测控设备做好必要的防护,保证设备在试验期间能正常工作。
2.2 测试程序流程
在试验过程中,主要的软件测试流程为:(1)在测控PC机上,启动测控软件,进行PC机与下位控制设备之间的通讯检测;(2)对下位测控板进行reset操作;(3)对试验样品的地址范围进行选择;(4)进行试验样品芯片ID识别操作;(5)对试验样品进行擦除操作;(6)检查试验样品的无效块分布情况;(7)对试验样品进行数据写入操作;(8)对试验样品数据写入正确性进行检查。
2.3 试验样品准备
在单粒子效应试验研究中,选取的大容量NAND Flash存储器为三星电子公司生产的8G存储器和16G存储器,器件性能和参数可参见产品数据单介绍。
试验前,对器件进行了揭盖处理,器件揭盖后安装在测试板上,通过测试系统进行性能检测,以保证器件在揭盖后工作正常。图2为测试板上安装的两类待测试样器件图片。
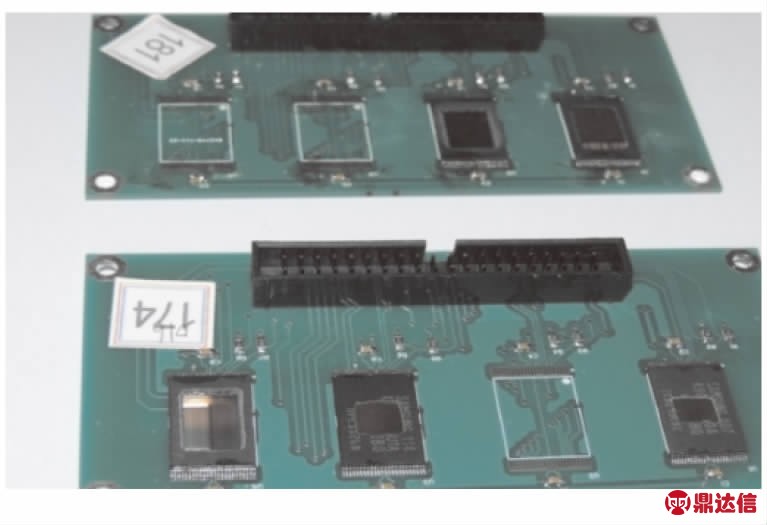
图2 试验DUT上安装的两类待测试样器件图片
Fig.2 Pictures of under test sample installed on the plate
试验中,选取的试验样品数总计为30片,经过揭盖处理后,工作性能仍正常的有20片。在测试板调试安装中,依据揭盖处理后的试验样品性能,共调试完成了4个测试板,其编号分别为DUT 174#、DUT 179#、DUT 180#、DUT 181#。
2.4 试验要求及过程
大容量NAND Flash存储器单粒子效应试验要求主要包括样品准备、设备连接、测试系统调试及一般试验流程等。试验设备主要包括上位监控机、下位测控机、测试板及电源等,试验时整套测试设备与试验设备终端进行连接。试验时,测试板用抬高板抬出,固定在束流定位的方向,NAND Flash存储器经过揭盖处理。被照射的NAND Flash存储器正常连接在测试板上,测试板通过电缆与外部的测试系统连接。
正确连接试验样品和测试仪器后,检查试验样品与测试系统通过接头的连接是否完好,并进行通电测试,以测试样品在不同测试模式下输出电压和输入电流的大小,确定样品工作是否正常。在试验现场,测试系统联调成功后,需进行1~2小时的考核调试试验,以明确可能出现的通讯失败的非单粒子事件因素。在重离子试验过程中,合理选择一定LET值的离子(射程大于30微米),调整束流特性(如能量、注量等)进行照射,通过数字电流表实时监测输入电流的大小,采用测控系统指示监测并记录单粒子事件数。
3 试验结果及分析
3.1 脉冲激光试验结果
3.1.1 试验现象及数据
利用聚焦脉冲激光束照射试验样品的具有明显不同形貌结构的存储阵列a类和b类,观察到了单粒子翻转、单粒子功能中断及单粒子锁定现象。图3为存储阵列a类辐照点示意图,图中十字准星位置为激光辐照点,在此辐照点上通过脉冲激光辐照检测到了单粒子翻转现象。
(1)单粒子翻转

图3 存储阵列辐照点示意图
Fig.3 The diagram of irradiation location on storage array
试验分别获取了存储阵列a类和b类辐照点翻转数据,如表1、表2所示。通过数据分析发现:1)对大量页的数据读取发现,在不同块、不同页的相同byte或相邻byte也发生了单粒子翻转。这说明激光能量在纵向上不仅仅是穿透了一个页,而是穿透了很多个页、很多个块。2)在读模式发生单粒子翻转后擦写也显示错误,说明存储阵列中发生硬错误。在发生翻转的位置经多次辐照,能够使数据恢复,但即使数据恢复,在执行擦除和编程操作时仍然显示擦写错误。另外,辐照过程中电流没有明显变化,但器件长时间运行后电流数值稍有增加,断电重启后恢复正常。这说明单粒子翻转并没有导致电流发生变化,电流数值稍有增加的原因是器件长时间工作所致。
表1 存储阵列(a)类辐照点翻转数据
Table 1 SEU data of storage array (a)
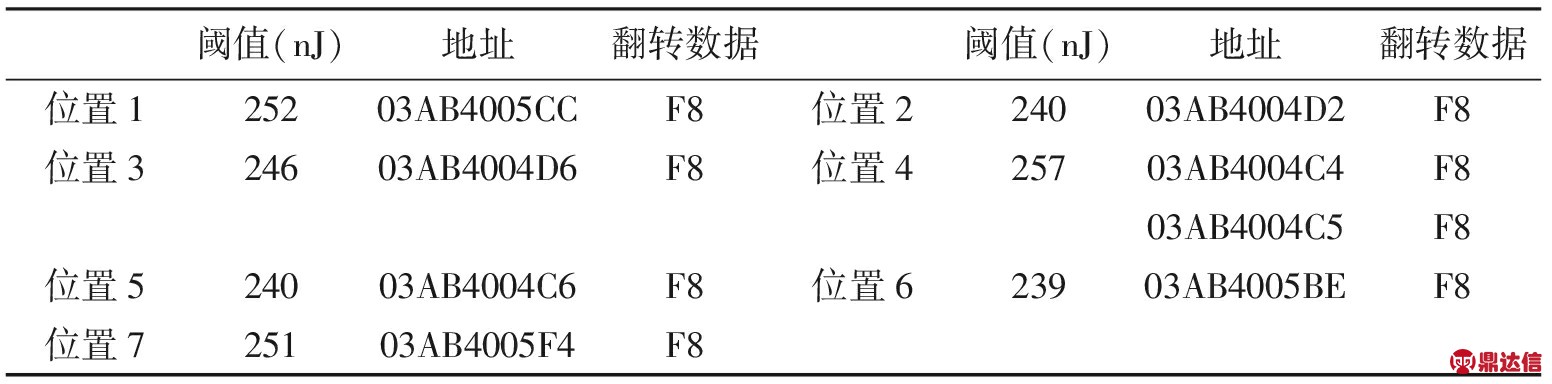
表2 存储阵列(b)类辐照点翻转数据
Table 2 SEU data of storage array (b)

(2)单粒子功能中断
利用聚焦脉冲激光束照射控制电路区域,观察到了单粒子功能中断现象;不同照射位置,脉冲激光能量阈值不同。其主要特征为:1)发生功能中断后,复位操作不能使器件从擦除操作跳出,重新上电后各种操作运行正常。2)发生功能中断时电流数值增加约15%,并且断电重启后,电流依然保持在高电流,但此种情况不应定义为单粒子锁定,因为尽管电流增大,但对器件进行擦写操作后依然运行正常,并没有发生灾难性失效。
(3)单粒子锁定
经过多次激光辐照,在激光能量为331nJ时发现单粒子锁定,系统电流数值由24mA增加到116mA,且断电重启后只能执行复位操作,其余操作均不能进行。但即使复位操作也不能使器件从擦除、编程、读取中断中退出。由此断定此现象为单粒子锁定,器件发生灾难性失效。
3.1.2 讨论分析
实验中发现激光辐照能够产生从“0”到“1”的翻转过程,也能产生从“1”到“0”的翻转过程。由于浮栅存储单元的存储状态由其携带的电荷量决定,所以,其发生单粒子翻转与否主要取决于浮栅在辐照条件下的电荷损失过程。在脉冲激光辐照条件下,浮栅上的电荷损失有以下几种情况:1)当辐射照射隧道氧化层时,产生的高密度等离子电子空穴对会形成很薄的瞬态导电路径,在器件内部同时伴随着局部氧化物势垒的降低;浮栅上存储的电荷可通过导电路径泄放出去。2)照射将在隧道氧化层及栅之间的绝缘层内产生空穴,如果这些空穴未被复合掉,则可能漂移到浮栅,与浮栅上的电子复合,使得浮栅上电荷减少。这种电荷的复合过程主要有两个方面:一方面,浮栅上的负电荷在氧化层中产生电场吸引空穴;另一方面,辐射产生的电子由于高的迁移率被很快推向体硅和控制栅,3)浮栅上的电子在辐照后会获得足够能量,可以跃过氧化层势垒,跃迁到体硅或者控制栅,导致浮栅上电荷减少,阈值电压发生变化。在辐照条件下,浮栅上的电荷量通过以上3种电荷损失机制发生改变,从而使存储单元的存储状态发生改变,导致单粒子翻转发生。
实验过程中也检测到了多位翻转,但是,NAND Flash存储器浮栅存储单元是相互独立的,又由于脉冲激光束是垂直入射的,所以,产生多位翻转的唯一原因只能是激光束覆盖到了许多个存储单元。这一点可以通过激光束尺寸与存储单元面积尺寸的比较加以说明。比如,试验样品器件K9F4G08U0B的特征尺寸为F=65nm,而NAND Flash一个存储单元的面积为4F2,实验中脉冲激光测试平台产生的脉冲激光束斑直径为2.5μm,从面积大小看,脉冲激光束斑覆盖了许多存储单元。无论单个位翻转还是多位翻转,在重新上电进行擦除和编程都不能使错误恢复。在室温下经过15天的退火后发现仅有少量错误能够恢复。这说明辐射导致的浮栅晶体管的栅穿是造成大量不可恢复的错误的原因。这与H.R.Schwartz等人[7]的研究结果不同。
实验过程中,当器件在“擦”模式运行的情况下检测到了单粒子功能中断和单粒子锁定,观察时序图可以知道实验样品的运行是在锁存地址和命令后通过内部微控制器执行的,在执行期间“忙信号”拉低,完成后“忙信号”拉高。所以,在时序上导致功能中断的环节只能是锁存命令的环节或者是内部微控制器执行命令的环节。但是,通过对样品执行读ID操作和复位操作,发现样品可以执行,这就排除了锁存命令时发生功能中断的可能。所以,能够确定是在内部微控制器执行擦除命令时脉冲激光辐照导致的功能中断。
3.2 重离子试验结果
3.2.1 试验现象及数据
在试验过程中,首先利用部分地址扫描方式观测NAND Flash存储器的单粒子翻转情况。试验中发现,对DUT 180# 板上的2#试验样品采用部分地址扫描方式测试时,在离子注量率约为103个/秒、离子总注量达到2.65×104 个/cm2时,在扫描的部分地址范围内观测到4次翻转;这说明重离子在NAND Flash存储器中诱发了器件内部浮栅电荷状态的变化。值得一提的是,在试验过程中,在部分地址实时扫描测试方式下,观测到翻转数有时会减少,这也许与NAND Flash存储器存储单元的存储状态由浮栅上的电荷量决定相关,浮栅晶体管的存储状态决定于浮栅上的电荷量,一旦重离子产生的电子空穴对导致浮栅电荷量发生改变,就可能导致浮栅晶体管的存储状态发生改变,进而导致单粒子翻转。可能在某些情况下,由重离子造成的电荷损失会在重离子作用下恢复到原来状态,具体过程需结合器件内部结构进一步开展分析研究。在采用脉冲激光进行辐照试验时,也发现了类似现象的存在。测试表明,当脉冲激光在发生翻转的位置多次辐照后,数据能够恢复到原来状态。
在试验过程中,也观测到了器件电流的变化情况:在重离子未辐照条件下,器件电流处在4.0mA~4.5mA之间;在重离子辐照过程中,器件电流有时会发生变化,不定期出现尖峰高电流的状态,最大为22.7mA;在重离子辐照过程中,如果器件出现这种高低电流变化状态时,几乎观测不到单粒子翻转现象,也许这种电流的变化限制了单粒子翻转现象的发生。
在试验过程中,对几个试验样品进行了未加电状态下的重离子辐照。试验测试结果表明,重离子在闪存存储器未加电状态下仍可诱发单粒子翻转。
3.2.2 试验数据及分析
利用试验获取的数据,计算了不同状态下的单粒子翻转截面。表3和表5分别给出了重离子辐照前后,DUT 180# 上4个试验样品和DUT 179#上3个试验样品(另一批次采购)的坏块变化情况。从表中可以看出,重离子辐照可以导致闪存存储器坏块的增加。表4和表6分别给出了重离子辐照后,DUT 180# 上4个试验样品和DUT 179#上3个试验样品(另一批次采购)的翻转数据情况。
表3 DUT 180# 试验样品辐照前后坏块变化数据表
Table 3 Changes of failure blocks of DUT 180# sample after irradiation

依据表3和表5数据,在重离子照射下存储器存储单元中的坏块分布会增加。从表中可以看出,当离子总注量处于约105离子/cm2数量级范围内时,造成的存储器坏块增量达到约0.7×104个。也就是说,能量为840MeV的Xe+平均每入射15个离子就可以诱发存储器存储单元中形成一个坏块。因此,在开展NAND Flash存储器单粒子效应试验评估中,重离子诱发的存储器坏块增加是需关注的一个方面。
表4 DUT 180# 试验样品翻转截面(注:4#未加电辐照)
Table 4 SEU Cross section of DUT 180# sample

表5 DUT 179# 试验样品辐照前后坏块变化数据表
Table 5 Changes of failure blocks of DUT 179# sample after irradiation

表6 DUT 179# 试验样品翻转截面(注:4#未加电辐照)
Table 6 SEU Cross section of DUT 179# sample
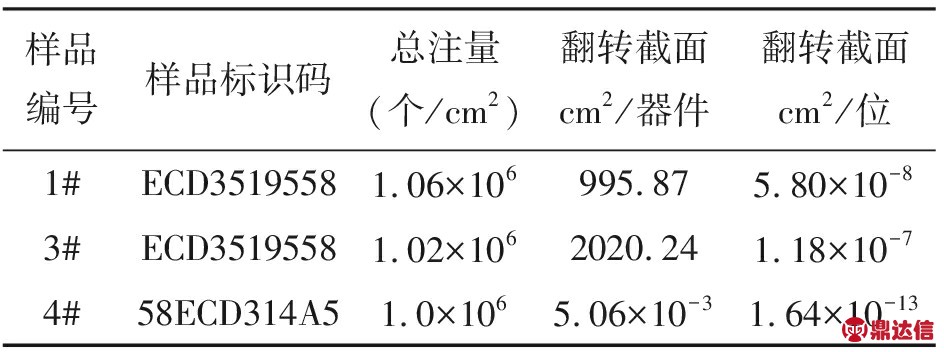
依据表4数据可以看出,在Xe+离子照射下,存储器单粒子翻转截面很高。其中1#和3#器件的翻转截面远高于器件芯片的面积,几乎是器件芯片面积(通常认为是翻转饱和截面)的近千倍;2#的翻转截面近似于器件芯片面积的10倍;而4#器件翻转截面近似于器件芯片面积。这里需要说明的是,1#和3#器件为同一种器件;2#和4#器件为同一种器件;4#器件在未加电情况下进行辐照,其他器件均在加电情况下进行辐照。
依据表6的试验数据可以看出,在Xe+离子照射下,存储器单粒子翻转截面也很高,但与表4给出的试验数据有一定的差异。这也许与器件的批次性相关,需要开展进一步分析研究工作。从表中可以看出,4#器件在未加电情况下进行辐照时,其单粒子翻转截面很低。
4 结论
脉冲激光单粒子效应实验发现,脉冲激光辐照存储阵列能够引起NAND Flash存储器发生单个位翻转和多位翻转,并且大部分翻转的位都发生了栅穿。但是对存储阵列的辐照,没有发生单粒子功能中断和单粒子锁定。应用脉冲激光对控制电路进行辐照时发生了单粒子功能中断与单粒子锁定现象。引起单粒子功能中断与引起单粒子锁定的激光能量值差异不大,但引起控制电路发生单粒子效应的激光能量要大于引起存储阵列发生单粒子效应的激光能量。由于商用器件内部电路结构的复杂性,其单粒子效应的产生机理还需要进一步研究。
采用LET值为65.60MeV·cm2/mg,射程为62.8μm的Xe+离子照射NAND Flash存储器试验发现:(1)在部分地址实时扫描测试方式下,观测到翻转数有时会减少,初步分析认为这与 NAND Flash存储器自身的存储结构相关。(2)在辐照过程中,器件出现高低电流变化状态,这种情况下发生单粒子翻转的概率很小。(3)重离子辐照可诱发存储器坏块增加,试验数据表明,能量为840MeV的Xe+平均每入射15个离子就可以诱发NAND Flash存储器存储单元中形成一个坏块。(4)在LET值为65.60MeV·cm2/mg、射程为62.8μm的Xe+离子照射下,存储器单粒子翻转截面很高,甚至达到器件饱和截面的几十倍。(5)试验过程中在未加电情况下进行辐照时,器件的单粒子翻转敏感性降低。



